全球先进封装市场参与者包括IDM类厂商、Foundry类厂商及OSAT类厂商。头部厂商在先进封装上普遍采用“大平台+技术分支”的架构,覆盖晶圆级、2.5D/3D封装等技术,形成覆盖全场景的封装解决方案。
英特尔
IDM丨Intel
Tech: FCBGA/ EMIB/ Foveros

英特尔代工的先进系统封装及测试(Intel Foundry ASAT)的技术组合,其核心技术包括 FCBGA、EMIB、Foveros 系列。
基础的FCBGA 2D及优化版FCBGA 2D+以低成本有机基板封装满足通用芯片需求;
EMIB技术通过嵌入基板的硅桥实现2.5D异构集成,而EMIB3.5D进一步引入3D堆叠提升带宽与密度;
Foveros系列则通过微凸块和TSV支持垂直堆叠(如Foveros3D),而最前沿的Foveros Direct采用铜-铜直接键合技术,实现最高的带宽和最低的功耗互连。
三星
IDM丨Samsung
Tech: I-Cube/ H-Cube/ X-Cube

HIT是三星的顶层封装技术平台,整合了2.5D、3D封装技术及异构集成方案。I-Cube、X-Cube、H-Cube属于HIT平台下的具体技术系列,而SAINT是3D封装子平台,进一步强化HIT能力。 I-Cube(2.5D封装技术)在布局设计上采用并行放置多个芯片,有效防止热量积存,提高了系统性能。该技术分为I-Cube S(适用于中小规模芯片集成)和I-Cube E(支持更大规模的多芯片异构集成,满足高性能计算需求)两个版本;
H-Cube(2.5D封装技术)支持逻辑芯片、存储芯片与其他功能芯片的混合封装,实现高度定制化的系统级解决方案;
X-Cube(3D封装技术)通过垂直堆叠芯片,节省空间并提升处理速度。该技术分为X-Cube 微凸块(适用于中等密度堆叠)和X-Cube 铜混合键合(采用更先进的键合技术,实现更高密度的3D集成)。
美光
IDM丨Micron
Tech: TC-NCF

TC-NCF是一种HBM内存堆叠工艺,用于多层DRAM芯片的垂直键合,通过热压技术将多层DRAM芯片垂直堆叠,其可减少层间间隙,提升堆叠密度,优化信号传输效率和散热性能,降低堆叠后的芯片翘曲问题。 
海力士
IDM丨Skhynix
Tech: MR-MUF

MR-MUF(批量回流模制底部填充)是一种通过熔化堆叠芯片间的凸点以连接芯片的技术。通过模制底部填充技术,将保护材料填充至堆叠芯片间隙中,以提高耐用性和散热性。结合回流和模制工艺,MR-MUF技术将半导体芯片连接到电路上,并用环氧树脂模塑料(EMC)填充芯片间及凸点间的空隙。 MR-MUF 是SK海力士专有的2.5D封装技术,也是为HBM3E开发的垂直堆叠优化技术,解决HBM堆叠层数增加带来的散热、机械强度和芯片翘曲问题。
台积电
Foundry丨TSMC
Tech: INFO/ coWoS/ SoIC

3D Fabric是台积电的封装技术总框架,包含前端SoIC系列、后端CoWoS与InFO系列。

InFO(集成扇出型封装)是台积电的2.5D封装技术,通过将芯片直接封装在基板上,无需传统的有机封装基板,从而实现更小的尺寸和更高的集成密度。该技术可细分为InFO-POP和InFO-LSI,InFO-POP是FOWLP(扇出型晶圆级封装)与POP(堆叠封装)的结合,而InFO-LSI是一种高带宽、低成本的异构集成技术,通过硅桥和RDL(重分布层)实现芯片间的互联,适用于需要更高互联密度的场景;
CoWoS(基板上的晶圆级芯片封装)是台积电的2.5D封装技术,通过硅中介层多个芯片集成到同一基板上,实现异构计算。该技术分为CoWoS-S(硅中介层)、CoWoS-R(重新布线层中介层) 和 CoWoS-L(混合中介层);
SoIC(系统级集成芯片)是台积电的3D垂直堆叠技术,其支持CoW(基板上晶圆)和WoW(多晶圆堆叠)方案,通过混合键合(Hybrid Bonding)直接将多层芯片堆叠,无需中介层或硅通孔(TSV),实现超高密度集成。而SoIC-P是台积电SoIC解决方案的微凸块版本,为3D芯片堆叠提供了一种经济高效的方式。
联华电子
Foundry丨UMC
Tech: W2W 3D IC

W2W 3D IC是联华电子主导的3D集成电路封装平台,旨在通过晶圆级堆叠技术实现多芯片异构集成,主要面向高性能计算(如AI、5G、汽车电子)和边缘计算场景。
W2W通过晶圆级键合(Wafer-on-Wafer)实现芯片堆叠,支持逻辑芯片与内存的异构集成,同时采用混合键合(HybridBonding)技术,实现纳米级对齐精度(<10nm),减少信号延迟,提升带宽。
盛合晶微
Foundry丨SJSEMI
Tech: SmartAip

SmartPoser是盛合晶微自主研发的三维先进封装技术平 台 , 其核心是通过异质集成 ( HeterogeneousIntegration)实现多芯片(有源/无源)的高密度、高可靠性三维堆叠。
SmartPoser的核心技术包括高密度再布线(RDL)、垂直铜柱互连(TIV)和晶圆级集成。
中芯国际
Foundry丨SMIC
Tech: FCBGA /EMIB /Foveros

中芯国际将封测业务外包给其他专业OSAT厂商完成。 如2014年中芯国际和长电科技合资成立的中芯长电。 2023年,中芯长电更名为盛合晶微,专注于先进封装技术(如凸块加工、2.5D/3D封装)。

日月光
OSAT丨ASE GROUP
Tech: FOPoP/ FOCoS/ FOSiP2.5D/3D IC

VIPack就是以3D异质整合为关键技术的先进互连技术解决方案。该平台由六大核心封装技术支柱组成,包括基于高密度RDL的FOPoP、FOCoS、FOCoS-Bridge、FOSiP,以及基于硅穿孔(TSV)的2.5D/3D IC和光电共封装(Co-Packaged Optics)。
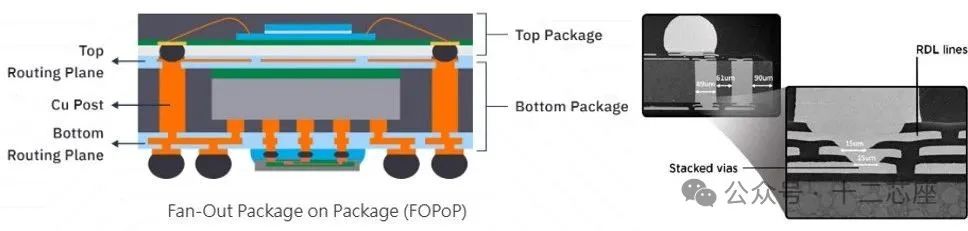
FOPop它将扇形底部封装与安装在顶部的标准封装相结合,并利用细间距镀铜柱进行过模垂直互连。底部封装有两个rdl(顶部和底部布线平面)由铜柱连接,铜柱由晶圆级扇出技术形成,可以实现更薄更细的电迹线。
安靠科技
OSAT丨Amkor
Tech: SWIFT/ SLIM/ HDFO

SWIFT是Amkor的先进高密度扇出技术,采用2/2μm线/间距设计,可替代2.5D TSV实现SoC分区及网络应用的高密度芯片互联;SLIM通过前道工艺在硅片无机介质层制作亚微米(≤1μm)金属布线;HDFO是基于SWIFT开发的异构芯片封装方案。
通富微电
OSAT丨TF
Tech: VISionS

通 富 微 电 拥 有九 大 封 装系列 , 覆 盖 全领 域 : 包 括FCBGA&FCCSP、FO、HVP、WLCSP、SiP等。通富微电目前已建成了融合2.5D、3D、MCM-Chiplet等先进封装技术的VISionS的先进封装平台及超大尺寸FCBGA研发平台。 VISionS是通富微电推出的先进封装技术平台,聚焦于高密度、高性能、异构集成需求,覆盖2.5D/3D封装、扇出型封装(Fan-out)及系统级封装(SiP)等领域。
华天科技
OSAT丨HT-Tech
Tech: 3D Matrix/ sSiFO/ eSinC 2.5D

华天科技大力发展SiP、FC、TSV、Fan-Out、WLP、2.5D、3D、Chiplet、FOPLP等先进封装技术和产品。

3D Matrix是华天科技整合先进封装技术的综合平台,由TSV(硅通孔)、eSiFO(硅基扇出)、3D SiP(三维系统级封装)三大核心技术构成。其中,硅基扇出型晶圆级封装(embedded Silicon Fan-out,eSiFO)是华天科技并具有自主知识产权的一种先进Fan-Out封装技术。
eSiFO技术广泛应用于电源管理芯片、射频收发器芯片、基带处理器和高端网络系统等多种应用领域;3D SiP是基于eSinC技术实现的。
eSinC 2.5D封装技术平台是面向2.5D先进封装赛道,包含三大2.5D技术门类,分别是硅转接板芯粒系统SiCS(Silicon interposer Chiplet System)、扇出芯粒系统FoCS(Fan out Chiplet System)和桥联芯粒系统BiCS(Bridgeinterconnection Chiplet System)。
长电科技
OSAT丨JCET
Tech: XDFOI

在先进封装领域,长电科技拥有多项行业领先的技术,包括SiP(系统级封装)、FC(倒装)、WLCSP(晶圆片级芯片规模封装)、2.5D/3D、Bumping(凸块)、MEMS和PoP(堆叠封装)等。
XDFOI: 是新型无硅通孔晶圆级极高密度封装技术,相较于2.5D 硅通孔(TSV)封装技术,具备更高性能、更高可靠性以及更低成本等特性。该解决方案在线宽或线距可达到2um的同时,可实现多层布线层,另外,采用了极窄节距凸块互联技术,封装尺寸大,可集成多颗芯片、高带宽内存和无源器件。其利用协同设计理念实现了芯片成品集成与测试一体化,涵盖2D、2.5D、3D Chiplet 集成技术。
甬矽电子
OSAT丨FHEC
Tech: FHBSAP/ RWLP/ HOCS

FHBSAP 涵盖RWLP系列(晶圆级重构封装,Fan-out扇出封装)、HCOS系列(2.5D晶圆级/基板上异构封装)、Vertical系列(晶圆级垂直芯片堆栈封装)等,精准适配Fan-out(FO)、2.5D/3D先进晶圆级封装等多元化先进封装技术需求,助力AI、汽车电子等高端芯片国产化。
深科技
OSAT丨KAIFA
Tech: FC/ POPt/ SiP

深科技的封装技术主要通过其控股子公司深圳沛顿科技及合肥沛顿实现,专注于高端存储芯片封装与测试。
深科技已完成了16层堆叠技术的研发,并具备了量产能力。超薄POPt(Package-on-Package with Through-substrate via)封装技术是一种先进的三维集成封装解决方案,通过在封装基板中形成穿透基板的通孔(TSV)实现不同层之间的电气连接,允许多层芯片垂直堆叠且封装高度较薄。其优势包括小型化、高性能和高可靠性,广泛应用于移动设备和便携式电子产品。未来,该技术将向更薄、更高密度互连方向发展,同时需应对封装翘曲等问题。
芯德科技
OSAT丨JSSI
Tech: FOCT-R/ FOCT-S

六大核心封装技术:高密度重布线扇出结构(FOCT-R)、高密度硅通孔扇出结构(FOCT-S)、重布线及硅基埋入基板扇出结构 (SETiS/RETiS)、叠层芯片扇出结构(TMV-POP)、玻璃基扇出结构(TGV-POP)、树脂/干膜扇出结构(eWLB-F/eWLB-M)。
中科智芯
OSAT丨ASMeIT
Tech: FC/ WLCSP/ SiP

产品主要集中在凸晶(点) /微凸点(Bumping/Micro-Bumping/Gold Bump ) 、 晶圆级芯片封装(WLCSP)、扇出型封装(FOWLP)、三维堆叠与系统集成封装 (3D Packaging & SiP)。

大港股份
OSAT丨大港股份
Tech: FC/ WLP/ SiP

晶圆级芯片封装的 TSV、Micro-Bumping(微凸点)和RDL等先进封装核心 技术,包含了覆盖锡凸块、铜凸块、垂直通孔技术、倒装焊等技术。
自主研发出FC、Bumping、MEMS、WLP、 SiP、TSV、WLFO等多项集成电路先进封装技术和产品。产品主要集中在凸晶(点) /微凸点(Bumping/Micro-Bumping/Gold Bump ) 、 晶圆级芯片封装(WLCSP)、扇出型封装(FOWLP)、三维堆叠与系统集成封装 (3D Packaging & SiP)。
为促进行业发展,互通有无,欢迎芯片设计、晶圆制造、装备、材料等产业链上下游加入艾邦半导体先进封装产业链交流群。

长按二维码,关注公众号,同步底部菜单申请加入
活动推荐:
第二届玻璃基板TGV及板级封装产业高峰论坛(8月26-27日,深圳) 同期展会:2025年玻璃基板及封装产业链展览会(8月26-28日) 序号
议题
公司
1
TGV集成三维互联核心材料技术
华中科技大学温州先进制造研究院李运钧研究员
2
涂布、干燥、贴膜工艺设备于玻璃基板及扇出型封装的应用趋势与挑战
群翊工業李志宏副總经理
3
Evatec先进封装基板FOPLP刻蚀和溅射方案
Evatec China 技术市场总监 陆原博士
4
TGV玻璃通孔激光加工中的基础问题和极限探究
南方科技大学教授徐少林
5
基于SLE(选择性激光蚀刻)工艺的精密玻璃加工——机遇、挑战与解决方案
Precise glass fabrication by SLE – opportunities, challenges, and solutions
Workshop of Photonics/凌云光技术股份有限公司 (VP of Business Development and Innovation) Martynas Dagys
6
基于Holotomography(HT)的玻璃基板三维无损检测与良率提升策略
韩国Tomocube 销售经理 金泳周
7
玻璃基板封装关键工艺研究
中科岛晶产品经理徐椿景
8
Next in Advanced Packaging: Why Glass Core Substrates is emerging
YOLE Bilal HACHEMI
9
玻璃基板原材料的技术及其应用
拓科达科技(深圳)有限公司/NEG 日本电气硝子 蔡岱峯 技术总监
10
应用于三维封装的PVD 系统
深圳市矩阵多元科技有限公司董事长张晓军
11
高精度非接触测量机在玻璃基板已经ABF载板行业中的应用
Mitutoyo/三丰精密量仪(上海)有限公司 营业技术部部长 李斌
12
TGV导电互连全湿法制备技术
深圳大学教授符显珠
13
玻璃芯基板:新一代先进的封装技术(待定)
安捷利美维电子(厦门)有限责任公司
14
议题拟定中
亚智系统科技(苏州)有限公司Manz亚智科技事业开发部副总经理 简伟铨 Adam
15
薄膜沉积技术在TGV制造中的应用
广东汇成真空科技股份有限公司研发部项目经理覃志伟
16
议题拟定中
芯和半导体科技(上海)有限公司
17
议题拟定中
深圳先进材料研究院
19
议题拟定中
希盟科技(3个议题)
20
议题拟定中
牛尾贸易(上海)有限公司
22
议题拟定中
施密德集团公司SCHMID Group N.V.
报名方式一: 加微信李小姐:18823755657(同微信)
邮箱:lirongrong@aibang.com

扫码添加微信,咨询会议详情
注意:每位参会者均需要提供信息
方式二:长按二维码扫码在线登记报名

或者复制网址到浏览器后,微信注册报名
https://www.aibang360.com/m/100255?ref=172672
点击阅读原文即可报名玻璃基板论坛!
为促进行业发展,互通有无,欢迎芯片设计、晶圆制造、装备、材料等产业链上下游加入艾邦半导体先进封装产业链交流群。

长按二维码,关注公众号,同步底部菜单申请加入
为促进行业发展,互通有无,欢迎芯片设计、晶圆制造、装备、材料等产业链上下游加入艾邦半导体先进封装产业链交流群。

长按二维码,关注公众号,同步底部菜单申请加入
为促进行业发展,互通有无,欢迎芯片设计、晶圆制造、装备、材料等产业链上下游加入艾邦半导体先进封装产业链交流群。

长按二维码,关注公众号,同步底部菜单申请加入
序号 | 议题 | 公司 |
1 | TGV集成三维互联核心材料技术 | 华中科技大学温州先进制造研究院李运钧研究员 |
2 | 涂布、干燥、贴膜工艺设备于玻璃基板及扇出型封装的应用趋势与挑战 | 群翊工業李志宏副總经理 |
3 | Evatec先进封装基板FOPLP刻蚀和溅射方案 | Evatec China 技术市场总监 陆原博士 |
4 | TGV玻璃通孔激光加工中的基础问题和极限探究 | 南方科技大学教授徐少林 |
5 | 基于SLE(选择性激光蚀刻)工艺的精密玻璃加工——机遇、挑战与解决方案 | Workshop of Photonics/凌云光技术股份有限公司 (VP of Business Development and Innovation) Martynas Dagys |
6 | 基于Holotomography(HT)的玻璃基板三维无损检测与良率提升策略 | 韩国Tomocube 销售经理 金泳周 |
7 | 玻璃基板封装关键工艺研究 | 中科岛晶产品经理徐椿景 |
8 | Next in Advanced Packaging: Why Glass Core Substrates is emerging | YOLE Bilal HACHEMI |
9 | 玻璃基板原材料的技术及其应用 | 拓科达科技(深圳)有限公司/NEG 日本电气硝子 蔡岱峯 技术总监 |
10 | 应用于三维封装的PVD 系统 | 深圳市矩阵多元科技有限公司董事长张晓军 |
11 | 高精度非接触测量机在玻璃基板已经ABF载板行业中的应用 | Mitutoyo/三丰精密量仪(上海)有限公司 营业技术部部长 李斌 |
12 | TGV导电互连全湿法制备技术 | 深圳大学教授符显珠 |
13 | 玻璃芯基板:新一代先进的封装技术(待定) | 安捷利美维电子(厦门)有限责任公司 |
14 | 议题拟定中 | 亚智系统科技(苏州)有限公司Manz亚智科技事业开发部副总经理 简伟铨 Adam |
15 | 薄膜沉积技术在TGV制造中的应用 | 广东汇成真空科技股份有限公司研发部项目经理覃志伟 |
16 | 议题拟定中 | 芯和半导体科技(上海)有限公司 |
17 | 议题拟定中 | 深圳先进材料研究院 |
19 | 议题拟定中 | 希盟科技(3个议题) |
20 | 议题拟定中 | 牛尾贸易(上海)有限公司 |
22 | 议题拟定中 | 施密德集团公司SCHMID Group N.V. |
加微信李小姐:18823755657(同微信)
邮箱:lirongrong@aibang.com

扫码添加微信,咨询会议详情
注意:每位参会者均需要提供信息
方式二:长按二维码扫码在线登记报名

或者复制网址到浏览器后,微信注册报名
https://www.aibang360.com/m/100255?ref=172672












