
汇集半导体行业资讯 技术前沿、发展趋势!
越亚半导体铜柱增层法技术领跑全球、3 纳米 ASIC 封装实力撑起百亿估值!
2025 年 9 月 30 日,深交所的这则受理公告,瞬间让半导体封装圈沸腾起来。珠海越亚半导体创业板 IPO 的正式启动,标志着国产封装力量向全球高端市场发起了一场强势冲锋。此次 IPO,中信证券为其保驾护航,计划募资 12.24 亿元,估值区间在 122 亿 - 194 亿之间。

陈先明CEO(首席执行官),公司创始人
在半导体产业链中,封装是芯片实现商用的关键“最后一公里”,而封装载板更是其中的“卡脖子”核心环节。长期以来,全球 80%以上的封装载板市场被日韩台企业垄断,国内企业只能在中低端领域艰难挣扎。然而,越亚半导体凭借自身的努力和创新,已经成长为一家具有一定国际竞争力的封装载板企业。

目前,越亚半导体的产品得到了 A 公司、威讯(Qorvo)、德州仪器(TI)、展讯通信、卓胜微、唯捷创芯、芯原微等国内外优质客户的广泛认可,并形成了稳定的供应关系。此次,越亚半导体带着 9907 万 - 1.57 亿股的发行计划叩关创业板,其底气正是来源于 2025 年上半年 8.11 亿元的营收以及服务英飞凌、长电科技等百余家巨头的封装硬实力。这场 IPO,不仅是越亚半导体自身发展的一个重要里程碑,更是国产封装载板打破海外垄断的“宣言书”。

越亚半导体是全球首家用“铜柱增层法”量产无芯封装载板的企业。这一创新技术直接跳过了传统封装载板对“芯”的依赖,使得封装体积更小、性能更强。通过采用铜柱增层法,越亚半导体能够在不依赖传统芯板的情况下,实现封装载板的制造,大大提高了封装的集成度和性能。
越亚半导体在封装技术领域成果斐然。率先实现 FC - BGA 载板国产化,此技术曾被日韩台企业垄断,是高端 CPU、GPU 封装关键,越亚突破后打通国产高端芯片封装“堵点”,降低进口依赖,提升国产芯片全球竞争力。
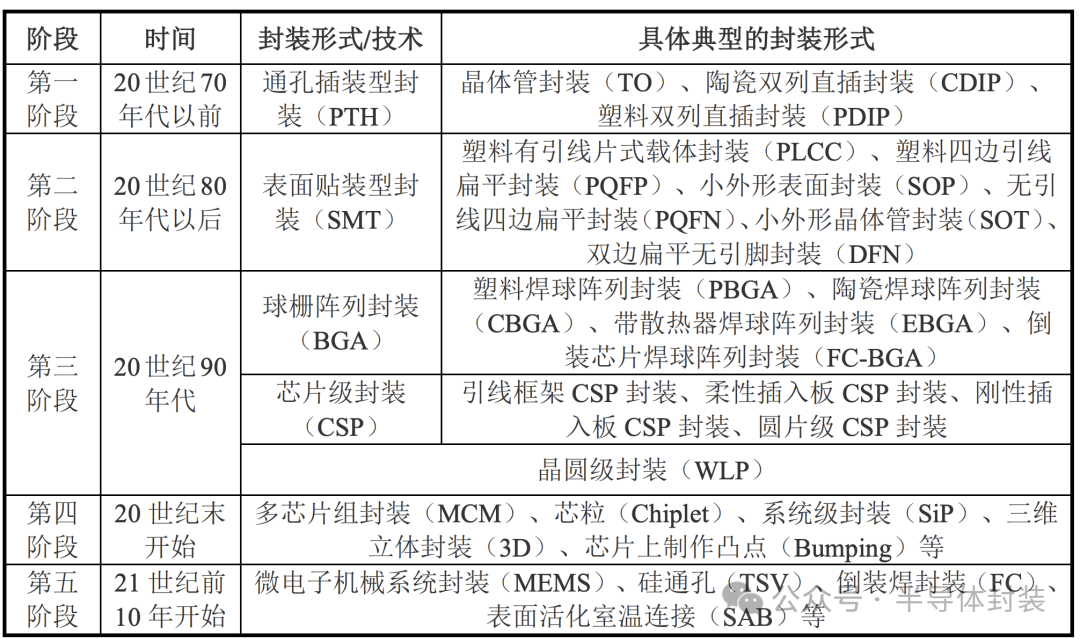
同时,作为全球少数实现嵌埋芯片产业化的企业,2017 年便量产嵌埋封装模组,提升封装密度与散热效率,为芯片小型化、高性能化提供新方案。
从 2009 年射频模组封装载板产业化,获国家级“制造业单项冠军产品”,到量产 3 纳米节点 ASIC 芯片封装载板、推进 Chiplet 封装载板认证,越亚紧跟封装技术前沿。其 IC 封装载板产品既广泛应用于 BGA、CSP 等主流封装形式,又积极在 MCM、Chiplet 等先进封装领域开展前沿研发与量产探索,证明国产封装已从“跟跑”变“领跑”。

12.24 亿元的募资投向,充分体现了越亚半导体深耕封装赛道的野心。其中,10.37 亿元将砸向“面向 AI 领域的高效能嵌埋封装模组扩产”,1.07 亿元用于升级研发中心。这一波操作精准地踩中了 AI 时代的封装需求爆发点。
随着 AI 服务器、算力中心的普及,传统封装已经无法满足芯片的高算力、高散热需求。而嵌埋封装模组能够让芯片“瘦身”又“提速”,正是 AI 芯片的“最佳搭档”。越亚半导体此次募资扩产,旨在进一步提升在 AI 封装领域的产能和技术水平,抢占未来市场的制高点。

如今,越亚半导体的封装产品早已渗透到半导体核心场景。在 5G 基站领域,其电源管理模组发挥着重要作用;在手机射频前端,封装载板为信号传输提供了可靠保障;在高端 CPU/GPU 领域,FC - BGA 载板打破了海外垄断。此次冲关创业板,不仅是为封装技术研发“输血”,更是要扛起国产高端封装的“大旗”。
*声明:本文系原作者创作。文章内容系其个人观点,我方转载仅为分享与讨论,不代表我方赞成或认同,如有异议,侵权欢迎联系我们删除!

▎往期推荐










