本文深度剖析荷兰半导体设备巨头Besi如何以混合键合技术撬动全球先进封装变革。面对AI与高性能计算芯片对3D集成的爆发性需求,传统封装技术已逼近物理极限。Besi凭借<10nm级键合精度与晶圆级集成方案,成为台积电SoIC、英特尔Foveros等尖端架构的核心赋能者。文章全景解析技术原理、产业链布局及商业落地路径,揭示Besi与应材结盟、卡位HBM/CPO市场的战略野心,更预判2026年476亿欧元市场爆发在即——这不仅关乎单点技术突破,更将重塑全球半导体制造权力格局。欢迎感兴趣的读者转发与关注!
随着AI和高性能计算(HPC)的飞速发展,芯片架构正朝着3D堆叠、小芯片(Chiplet)分解和异构集成的方向转变。这些技术的实现,很大程度上依赖于键合技术的持续突破和可扩展的大规模生产。在这一领域,有一家公司长期占据着关键地位——总部位于荷兰的BE半导体工业公司(Besi)。Besi:从平面封装向3D先进封装转型的关键推动者Besi成立于1995年,总部位于荷兰杜伊文(Duiven),在马来西亚、中国、新加坡和美国设有制造、研发和服务机构。该公司专注于设计和制造用于半导体后端工艺的高精度组装设备,尤其针对先进逻辑芯片、存储器、传感器和光子器件。Besi的产品组合涵盖从传统的2D封装到尖端的2.5D和3D封装技术,在以下四个核心领域表现出色:Besi在芯片贴装设备领域占有42%的市场份额,多年来保持全球领先地位。其产品系列涵盖环氧树脂贴装、软焊料贴装、倒装芯片、堆叠芯片和多模块应用。Besi的旗舰产品Datacon和Esec平台提供±4μm @3σ的精度,能够实现高速、高良率的制造,并具有超精细的芯片间距——非常适合性能关键型应用。随着AI、5G、HPC和基于小芯片的模块的兴起,Besi的先进封装解决方案已成为关键使能技术。2025年第一季度,Besi的订单接收量增长了8.2%,达到1.319亿欧元,其中混合键合订单是主要驱动力。https://www.besi.com/products-technology/product-details/product/datacon-8800-chameo-ultra-plus-ac/混合键合是Besi技术路线图的核心。作为垂直芯片堆叠和高密度互连的关键使能技术,它带来了更低的延迟、更低的能耗以及增强的带宽/系统性能。·<10nm对准精度: Besi的设备能够实现铜-氧化物和氧化物-氧化物的原子级键合,这对于3D集成至关重要。·热压集成: 像8800 CHAMEO ultra plus AC这样的平台结合了洁净室级键合和光学对准,确保了高良率和紧密间距的堆叠。·2024年,Besi接收了具备100nm对准能力的混合键合系统订单,表明其已为下一代节点做好准备。·自2020年起与应用材料公司(AMAT)建立战略合作伙伴关系,并在2025年深化合作,当时AMAT成为Besi的最大股东(持股9%),实现了从沉积到最终组装的紧密集成。·在2025年投资者日上,Besi将混合键合提升为核心业务支柱,并将长期收入目标提高至15-19亿欧元,运营利润率目标为40-55%。·《金融时报》报道称,混合键合收入在2023年为3600万欧元,预计到2026年将激增至4.76亿欧元,可能占到Besi总业务的三分之一。·Besi凭借其卓越的精度(<10nm)、高良率控制和超精细互连密度,在混合键合领域处于领先地位,将自己定位在AI、HBM和3D-IC封装创新的前沿。·与应用材料公司和ASML一起,Besi是推动混合键合进入大规模生产的垂直整合供应链的一部分。随着AI基础设施和数据中心需求的不断增长,Besi正成功地将混合键合从一项利基技术转变为一个主要的收入引擎,展现出强劲的长期增长潜力。为什么我们应该关注混合键合技术?
挑战是什么,AI芯片的先进封装将走向何方?
这些都是值得探讨的关键问题。例如,台积电(TSMC)正在积极推进其SoIC技术,其本质上就是一种3D堆叠架构。这反映了整个行业向更高集成度和性能的更广泛转变。
混合键合:3D芯片设计新时代的核心使能技术
混合键合被认为是自极紫外(
EUV)光刻技术以来半导体制造中最具变革性的创新之一。它不仅显著提高了芯片堆叠的精度和性能,还重新定义了芯片设计师处理3D架构和系统集成的方式。
虽然EUV专注于在单个芯片内的微缩,但混合键合则在字面上开辟了一个新的维度——实现了多个芯片的垂直堆叠。它已成为推动先进封装和高性能计算发展的关键技术。
在半导体行业中,键合技术对于实现异构集成和高密度3D堆叠架构起着关键作用。随着3D IC、基于小芯片的设计和先进封装技术持续获得关注,传统的基于凸块或焊料回流的方法越来越无法满足更精细间距和高速数据传输的需求。相比之下,涉及晶圆对晶圆(W-W)或芯片对晶圆/芯片对芯片(D-W / D-D)对准和互连的混合键合,已成为驱动高性能计算(HPC)、AI芯片和存储器堆叠的主流解决方案。
根据TEL的说法,键合技术现在广泛应用于各种器件类型,包括CIS图像传感器、3D NAND、DRAM、逻辑IC、背面供电(PDN)、顺序CFET,以及诸如HBM和分解式小芯片等先进封装场景。每种应用都需要不同水平的键合精度和互连间距——从早期存储器堆叠的40µm,到下一代小芯片架构所需的亚微米甚至<1µm互连。
在先进封装中,混合键合不仅增加了
I/O密度并改善了信号完整性,还实现了低功耗、高带宽的异构集成。它是台积电SoIC、三星X-Cube和英特尔Foveros等主要3D封装平台背后的基础技术。展望未来,随着逻辑和存储器的堆叠变得更加紧密耦合,带宽要求持续上升,键合技术的重要性只会与日俱增——成为芯片和系统层面创新的关键使能者。
*原文媒体:Semi Version
*原文链接:
https://tspasemiconductor.substack.com/p/hybrid-bonding-at-scale-besis-vision
2025湾芯展-技术论坛预告(2025.10.15-10.17)











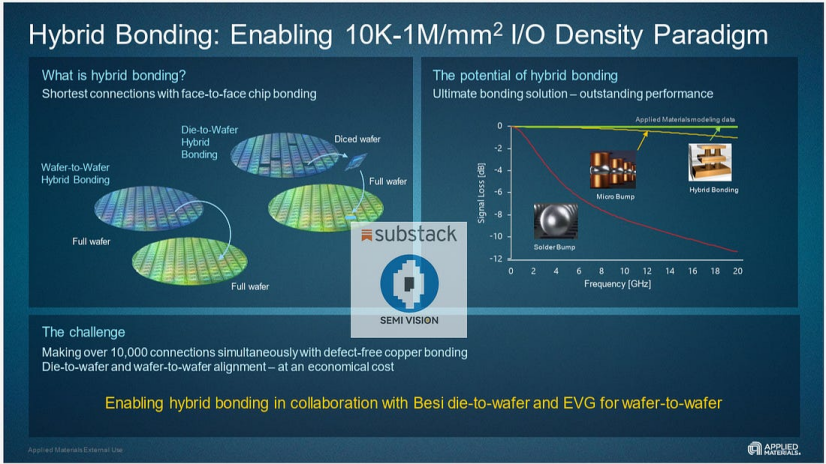










![2025年中国千兆三层交换机行业政策、发展现状及未来趋势分析:算力基建与AI需求共振,驱动行业高速增长[图]](https://xtechcon-static.oss-cn-chengdu.aliyuncs.com/xtimes/xtimes/images/2026-02-27/69a0ed1091c9c.jpeg)








![2025年中国金属基3D打印材料行业发展现状、企业布局及未来趋势分析:技术驱动一体化创新破局,应用向规模化量产跨越[图]](https://xtechcon-static.oss-cn-chengdu.aliyuncs.com/xtimes/xtimes/images/2026-02-28/69a23e9e294d8.jpeg)