
在后摩尔时代,半导体工艺逼近物理极限,2.5D/3D封装成延续摩尔定律的关键,中介层作为芯片“桥梁”影响重大。传统硅基中介层性能佳但成本高(占封装成本30%以上)、工艺难;有机中介层成本低但高频损耗大,且热膨胀系数较高,翘曲较大,难满足高密度互连需求;而基于TGV技术的玻璃基中介层,凭借优异射频性能、低膨胀系数(匹配性好)、高机械强度及成本优势,成下一代先进封装核心材料。虽国际巨头已布局,国内此前未量产突破,但其在HPC、AI、5G等领域潜力巨大,未来有望成高端封装主流,推动行业革新。
芯德半导体凭借在2.5D封装领域的深厚技术积淀,持续深耕创新。近期,芯德半导体与东南大学史泰龙团队联合研发的晶圆级Glass Interposer 2.5D扇出型封装技术取得突破性进展,相关技术指标均精准达成封装设计需求。本次流片的首颗样品为面向AI加速芯片的2.5D集成模块,该模块包含1颗采用7nm工艺的国产GPU核心、4颗单颗带宽超460GB/s的HBM2E存储芯片,以及厚度为400μm的Glass Interposer互连层,整体架构为高性能AI计算提供了强大的硬件支撑。

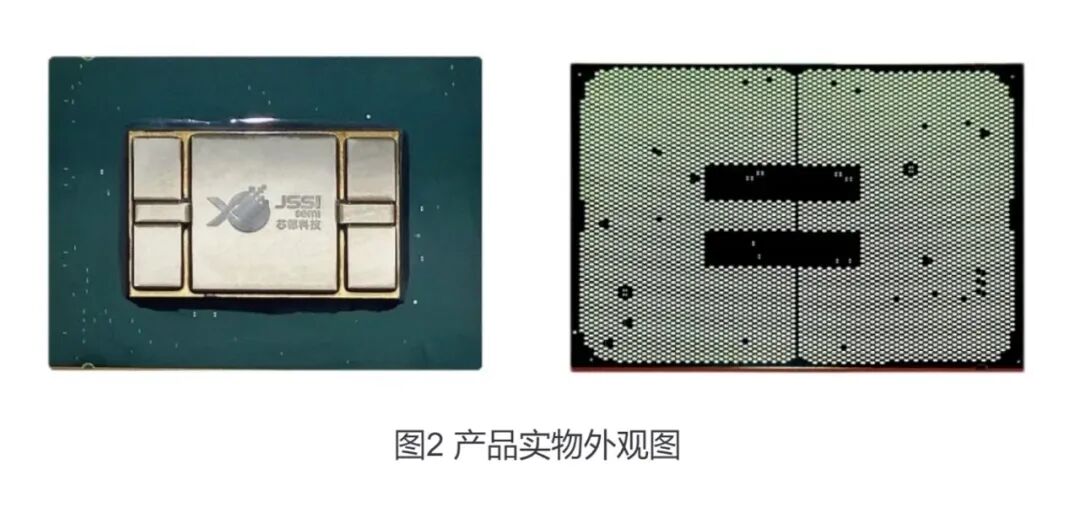
仿真数据显示: 在相同频率下,TGV互连结构插入损耗均小于TSV;比特率增加,眼图指标绝大部分均恶化,TGV指标仍均优于TSV。

1、高精度TGV(Through Glass Via)工艺:实现直径62.5μm的微孔加工,深宽比达7:1,互连密度提升3倍;
2、超细线路RDL(再布线层):线宽/线距≤2μm,支持10⁴I/O/mm²的高密度互连,满足HBM(高带宽存储器)集成需求;
3、低翘曲晶圆级封装:通过材料优化与低温键合技术,将300mm晶圆翘曲控制在<50μm,良率突破97%;
4、射频性能优化:玻璃介电损耗(Df)可低至0.004@10GHz,同样适用于5G毫米波、光通信等高频应用。

来源:芯德半导体官微

序号 | 拟定议题 | 演讲单位 |
1 | PEEK材料在半导体不同制程中的应用 | 邀请中 |
2 | PPS材料在半导体领域的应用 | 邀请中 |
3 | 半导体级PP材料应用与研究 | 邀请中 |
4 | 特种工程塑料型材在半导体设备领域应用 | 邀请中 |
5 | 氟塑料在酸碱制程中的耐腐蚀性能极限测试方法论 | 邀请中 |
6 | 半导体级氟塑料国产化进展 | 邀请中 |
7 | 半导体级氟塑料(PFA)管材挤出工艺 | 邀请中 |
8 | 氟橡胶在半导体设备密封领域的应用 | 邀请中 |
9 | 高性能橡胶在半导体制造热管理中的创新应用:耐高温密封与高效散热技术 | 邀请中 |
10 | 半导体晶圆传输系统橡胶缓冲材料的抗损伤与抗静电协同优化技术 | 邀请中 |
11 | 塑料晶圆载具中的应用 | 邀请中 |
12 | IC托盘材料选型 | 邀请中 |
13 | CMP保持环材料耐磨性提升 | 邀请中 |
14 | 晶圆清洗花篮的材料介绍 | 邀请中 |
15 | 先进封装光罩盒的新需求 | 邀请中 |
16 | 半导体微污染控制:析出物检测与工艺适配 | 邀请中 |
17 | 抗静电ABS在半导体制程中的应用 | 邀请中 |
18 | 抗静电PC/PVC洁净室板材表面处理技术 | 邀请中 |
19 | 全球PFAS法规收紧对含氟高分子供应链的影响与替代材料开发进展 | 邀请中 |
20 | 终端对半导体材料的需求及应用趋势 | 邀请中 |
更多议题征集中,创新演讲及赞助请联系Mickey周小姐: 18320865613(同微信)
报名方式一:加微信并发名片报名
电话:艾果儿 18312560351(同微信)
邮箱:ab008@aibang.com

扫码添加微信,咨询会议详情
注意:每位参会者均需要提供信息
报名方式二:

或者复制网址到浏览器后,微信注册报名:
https://www.aibang360.com/m/100258?ref=172672










