相关阅读
【内容目录】
2.全球领先背后的SerDes和PCB材料
3.结语
【湾芯展推荐】本文涉及的相关厂商
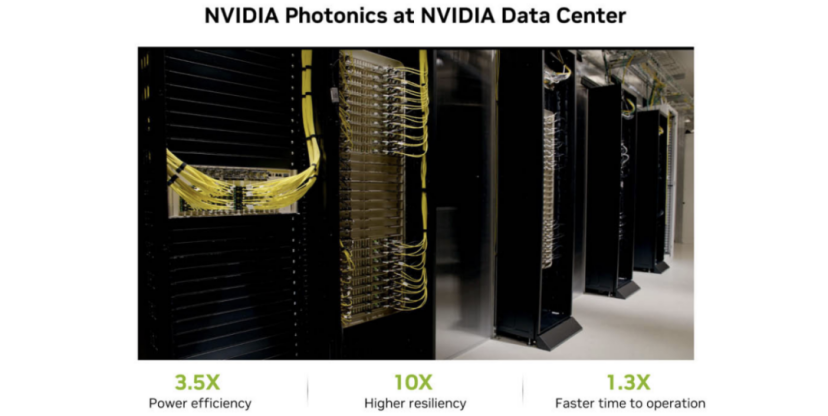
Nvidia数据中心的硅光子芯片(图源:NVIDIA)
数据中心逐渐从远程服务器向着AI算力中心和高性能计算中心所演变,I/O密度和宽带需求达到了前所未有的程度。就在八月末举行的 Hot Chips 2025 大会,Nvidia向业界展示了其最新的千兆级硅光子交换机的参数细节,无论是全球首发 200G/单通道 SerDes 还是Spectrum-X 硅光子信号完整性和电源完整性更上一个台阶,其背后都是CPO共封装技术、SerDes发展、PCB材料端的“革命性”发展。
技惊四座的硅光子交换机
根据大会上NVIDIA介绍,Spectrum-X将封装中光引擎(PIC)紧邻交换机的ASIC芯片,最小程度上缩短了PCB走线距离,并且1.6Tb/s信号链路的激光器也从8个减少到了2个;其在高算力负载下拥有更低的通信链路信号抖动和更高的能源效率。

Spectrum-X高性能以太网链接(图源:Nvidia)
对于超大规模云服务的OTS以太网链路,主要提供Web服务、数据库查询等松散耦合类应用,所以对于网络延迟和数据帧同步等要求较低,而算力中心需要分布式紧密耦合进程,最典型的就是万卡GPU集群训练,其所需算力节点要同步工作,所以数据延迟和同步起到决定性的作用;并且采用RoCE协议,可以远程直接进行内存数据访问,比标准TCP协议拥有更低的延迟和更小的CPU内核开销。需要特别指出的是,Spectrum-X Ethernet 对于抖动“零容忍”,数据包长尾效应会严重影响性能,只要有一个包延迟(长尾)则整个集群的速度和同步都收到影响,所以对于AI训练所特有的All-Reduce操作会产生的巨大瞬时burst流量来说,Spectrum-X Ethernet可以确保提供稳定可预测的高性能链路传输,为每个作业单元都尽可能的减少包延迟。
Nvidia 还介绍了,Spectrum-X采用的硅光子CPO芯片,拥有高达1.6Tb/s的带宽,封装内部集成了MRM(微环调制器),并且首次在光子芯片层和电子芯片层之间采用 3D 堆叠技术,极大程度上降低了布线复杂性并提高了带宽密度。不仅是Spectrum-X,Nvidia还展示了其首款集成光子技术的全尺寸交换机Spectrum-6 102T,相较于上一代产品其性能可谓“暴增”,2倍的数据吞吐量,1.6倍的带宽密度,60倍的信号完整性提升,激光器数量减少了3倍。

Spectrum-X CPO共封装硅光子交换机(图源:Nvidia)
Nvidia Green 团队与台积电在硅光子领域的合作日趋紧密,其背后更是数十门学科的不断精进,此次大会也着重提及了SerDes和PCB材料和信号布线层的未来挑战。
全球领先背后的SerDes和PCB材料
高性能AI服务器的算力单元核心任务就是两个,浮点运算和数据传输,GPU运算是由其核心主频所决定,数据传输的核心则是SerDes(串行器/解串器)接口的发展,从早期NRZ(28Gbps)到PAM4的56Gbps,再到现阶段主流的112G和即将商用的224Gbps Serdes,带宽的翻倍不仅来自于芯片的改进和封装的变革,底层材料学和PCB基板布线及工艺同样重要。在超高频下,信号完整性、插入损耗和热应力、机械应力下的信号和电源完整性缺一不可。
SerDes芯片第一梯队Marvell从2018年布局SerDes 的开发,在OFC 2025上展示了其3nm、224Gbps 的SerDes,拥有行业领先的超低功耗(<0.1 pJ/bit)、超高带宽密度(50+ Tbps/mm)和最低误码率 (BER) ,为CPO共封装光学器件和ASIC芯片间Die to Die互联提供了强有力的技术支持。

Marvell在OFC 2025的SerDes技术(图源:OFC 2025)
尤其是硅光子时代,SerDes和光链路从PCB外围的I/O逐渐走向芯片内核(共封装逐渐缩短连线距离,并且光电混合封装),电气、光学、封装和材料多种学科交织的全栈开发变得越来越困难,传统的IP开发要逐渐演变成复杂应用的解决方案,PCB材料端的更新重要性则越发凸显。国内给Nvidia提供高端、高精密多层PCB板的胜宏科技更是搭载上发展的快车道,一年时间内股价上涨近11倍,并且高端多层PCB行业也受到资本的青睐。
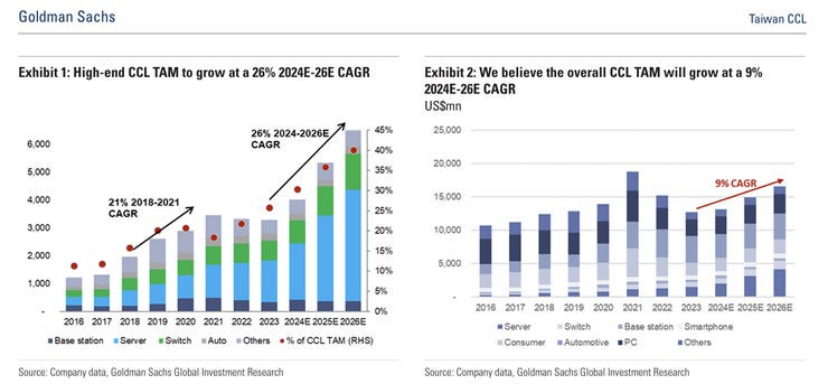
高端覆铜板市场CAGR(图源:Goldman Sachs)
2024年是高端覆铜板(CCL)市场结构性转变关键之年,每年高达26%的增长率,服务器、交换机等场景占比高达8成,许多制造商都推出了M8级覆铜板(例如松下Megtron 8)等超低损耗材料,松下Megtron 8材料其介电损耗因子(Df)约为0.0015,与上一代Megtron 7(Df≈0.002)相比,传输损耗降低了约25%,凭借其低介电常数和极低的信号损耗,正成为高精密多层PCB基材的不二之选。
据资料显示,目前112Gbps PAM4(约 28GHz)下,传统的 FR-4 和 HDI 材料已经难以承受, Df(耗散因数)和 CTE(热膨胀系数)已经不能满足进一步带宽的提升需求。目前业界更加看好松下的Megtron、韩国斗山和台湾的EMC EM-S532K材料。在台积电的CPO封装中,采用的EMC的EM-S570K3 和 EM-S572T 等新材料具有超低热膨胀系数 (CTE)(<2 ppm/°C)和高模量(>35 GPa), Df(耗散因数)也降低到0.003左右,在 80GHz 频率下将插入损耗降低了 35% 以上。在信号完整性如此重要的今天,PCB材料不再是被动的推动因素,而是高速信号链路的驱动力。
结语
随着TSMC引领的CPO封装投入量产,1.6Tb和3.2Tb交换机将成为业界主流,硅光子技术将引领基础科学迈向新的发展征程。AI算力性能的提升不单单是算力芯片的主频和信息链路的堆叠,基础封装架构(3D堆叠)和PCB基板材料(更小信号损耗和更好封装结构的热应力、机械应力)的提升才是整体性能提升的关键。
*参考资料
1.《Hot Chip 2025》
2.《Perspective on SerDes and CPO: PCB Material and Signal Routing Challenges Ahead》
3.Nvidia
文末福利:免费获取最全的行业资料信息汇总!
文末也给看到这的读者们发福利啦,深芯盟编辑近期分析了光学行业产业链,Yolo的最新分析报告也免费分享给读者朋友们,欢迎大家点赞和转发,我们下期再见。

关注本公众号并回复关键词:OIF,就可以领取每期给大家分享的行业资料啦!



芯启未来,智创生态














