英伟达于美国当地时间周二在华盛顿特区举办的 2025 年 GTC 大会主题演讲中,正式推出新一代 Vera Rubin 超级芯片。该芯片集成两块面向 AI 与高性能计算(HPC)的 Rubin GPU,以及一款定制化 88 核 Vera CPU。英伟达表示,这三大核心组件将于明年同期投入量产。
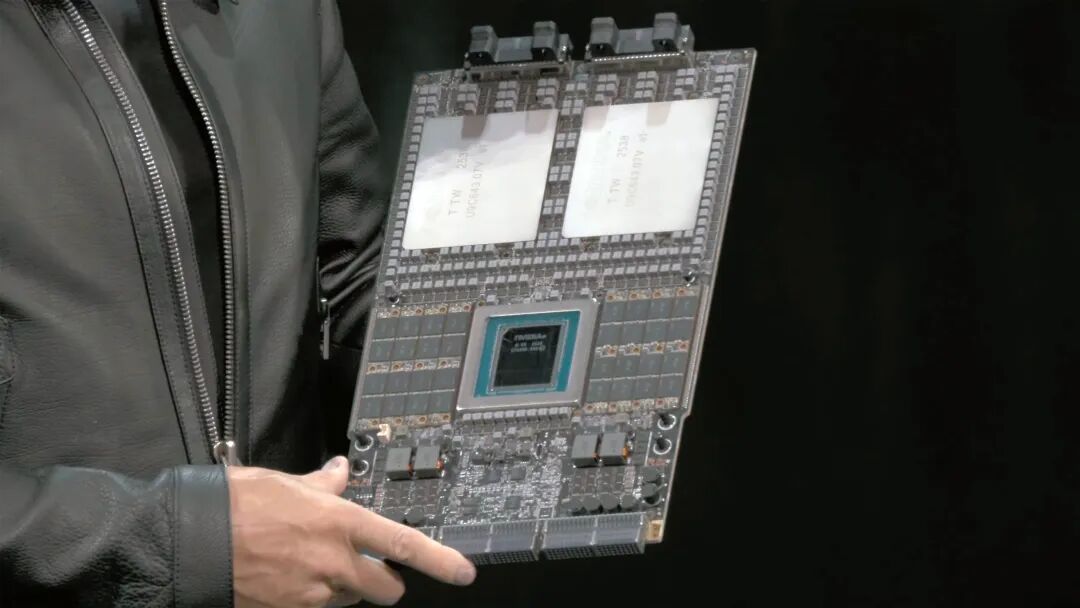
“这是新一代 Rubin 产品,” 英伟达首席执行官黄仁勋在 GTC 大会上指出,“我们当前正推进 GB300 芯片的交付,同时已着手准备 Rubin 的量产工作,预计明年同期甚至可能提前推出。…… 这是一款设计极为出色的计算产品,其 AI 场景下的 FP4 精度性能可达 100PFlops(千万亿次浮点运算 / 秒)。”
事实上,英伟达的超级芯片更接近“主板形态”(搭载于超厚印刷电路板上),而非传统意义上的 “单芯片”—— 这类产品通常集成定制化通用 CPU,以及两块面向 AI 与高性能计算负载的高性能运算 GPU。Vera Rubin 超级芯片同样遵循这一架构:主板中央是 88 核 Vera CPU,周围环绕 8 个搭载 LPDDR 内存的 SOCAMM2 存储模块,两块 Rubin GPU 则覆盖着大型矩形铝制均热板。
从 Rubin GPU 的标识可见,其封装产地为中国台湾,封装时间为 2025 年第 38 周(即 9 月末)—— 这一信息表明英伟达已对该款新处理器进行了一段时间的测试。由于均热板尺寸与 Blackwell 系列处理器相当,目前无法判断 Rubin GPU 的封装规格及运算芯片颗粒(chiplet)的具体尺寸。此外,Vera CPU 并非单块一体芯片,其表面可见明显的内部拼接痕迹,推测采用多芯片堆叠设计。

英伟达展示的主板图片进一步显示,每块 Rubin GPU 由两大运算芯片颗粒、8 组 HBM4 内存堆栈,以及 1-2 个 I/O 芯片颗粒组成。值得关注的是,此次展示的 Vera CPU 旁搭载了一颗辨识度极高的独立 I/O 芯片颗粒;同时图片中 CPU 芯片的 I/O 接口区域呈现绿色特征,其具体功能目前尚不明确。一种推测认为,Vera CPU 的部分 I/O 功能可能由 CPU 下方的外置芯片颗粒实现,但这一判断目前仍属推测,Vera 处理器的技术细节仍存在诸多待解之处。
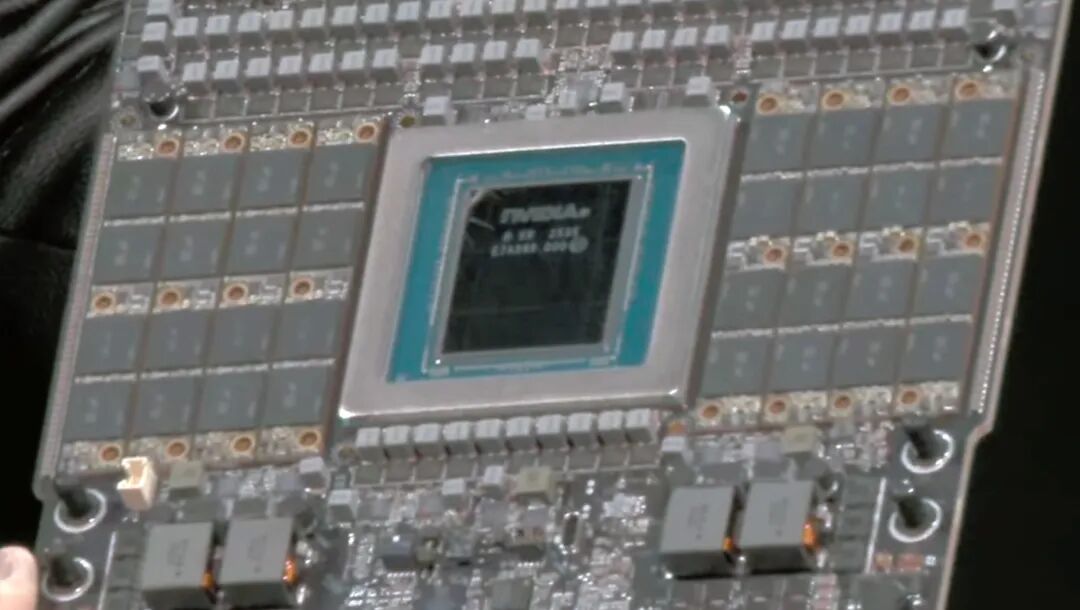
在接口设计上,Vera Rubin 超级芯片主板取消了行业标准的有线连接器插槽。主板顶部配备两个 NVLink 背板连接器,可将 GPU 与 NVLink 交换机相连,实现机架内的横向扩展;底部边缘则设有三个连接器,分别用于供电、PCIe 接口及 CXL 接口等功能。
综合来看,Vera Rubin 超级芯片的技术成熟度已较高。业内预计该产品将于 2026 年末开始交付,并在 2027 年初实现规模化部署。










