

A*STAR通过精密封装引领异构集成前沿
A*STAR的混合键合努力不仅限于单一工艺——它们涵盖了从晶圆对晶圆(W2W)、芯片对晶圆(C2W)、硅通孔(TSV)到多芯片堆叠和材料工程的完整技术栈。这种端到端的创新策略连接了:
1.清晰的技术路线图(例如,到2026年实现0.25μm间距的混合键合)
2.明确的量产化路径(通过保护层集成和先进堆叠)
3.与全球学术界和产业界的积极合作(例如,ECTC出版物和协作)
通过这些努力,A*STAR正将自身定位为全球范围内混合键合和异构集成演进的关键创新者。
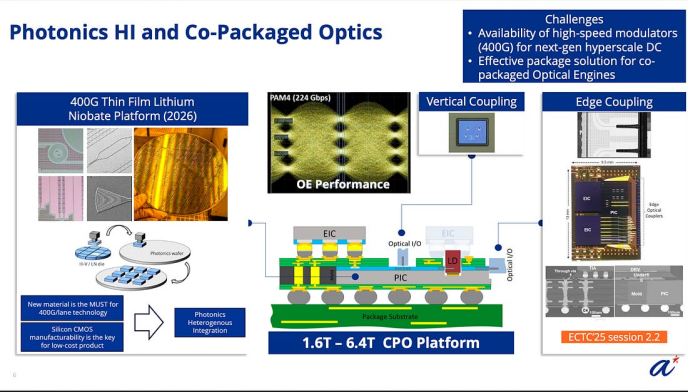

推动光电子异构集成(HI)和共封装光学(CPO)前沿:A*STAR面向未来数据中心的集成平台
随着人工智能(AI)、云计算和数据中心工作负载的持续激增,传统的基于铜的SerDes链路在带宽、能效和短距离互连可扩展性方面正接近其极限。共封装光学(CPO)已成为数据中心交换机和AI计算集群的下一代架构标准。
A*STAR战略性地聚焦于光电子异构集成(Photonics HI),正在加速开发一个能够支持每通道400G、总带宽范围从1.6T到6.4T的光引擎平台,目标是未来的超大规模数据基础设施。
关键挑战与A*STAR的应对
技术挑战:
·缺乏可大规模生产的高速调制器,尤其是用于400G PAM4信号调制的调制器。
·复杂的光子引擎封装,需要在电子集成电路(EICs)、光子集成电路(PICs)、激光二极管(LDs)和封装基板之间实现精确的光学对准和热管理。
A*STAR的解决方案:
·开发具有高线性度和超快调制能力的薄膜铌酸锂(TFLN)平台;目标是在2026年实现商业化。
·推进异构集成技术,在CMOS兼容平台上结合III-V族激光器、LN调制器和硅光电子学,以平衡性能和可制造性。
·设计1.6T至6.4T的光模块,提供支持边缘耦合(Edge Coupling)和垂直耦合(Vertical Coupling)架构的演示性原理图。
核心技术亮点
1. 400G 薄膜铌酸锂平台(目标:2026年)
·支持每通道224 Gbps的PAM4调制
·提供超低光学损耗和高带宽长度积
·非常适用于短距离、高速、低插入损耗的CPO应用
2. EIC + PIC + LD 异构集成
·结合电子集成电路(EICs)、光子集成电路(PICs)、激光二极管(LDs)和基板的多层集成
·通过集成驱动器和跨阻放大器(TIAs)实现双向光学输入/输出
3. 封装耦合方案:边缘耦合 vs. 垂直耦合
·边缘耦合:通过微透镜或倾斜波导进行水平耦合
·垂直耦合:使用微透镜(uLenses)、超透镜(meta-lenses)或硅反射器进行直接顶部耦合
·两种策略均与塑封、底部填充和热界面材料(TIMs)协同设计,以提高模块良率和稳定性
生态系统与平台集成
·支持基于CMOS的光电子集成,提高可制造性和可扩展性
·与CPO供应链保持一致,涵盖光子晶圆、激光器芯片、封装基板以及测试/验证流程
·研究在ECTC 2025会议第2.2分会场展示,表明学术界和工业界对A*STAR在光模块封装方面进展的高度认可
A*STAR将光子互连从实验室带入系统
从材料创新(如TFLN和III-V族异构键合)到工艺集成、耦合技术和系统级封装,A*STAR已构建了一个完整的“光电子HI + CPO平台”。它目前是亚太地区少数几个能够支持400G/通道光模块原型制作和中试制造的机构之一。
随着下一代数据中心基础设施从电气向光电融合过渡,A*STAR正引领潮流——通过尖端的异构集成和封装技术,实现更低延迟、更高能效和大幅增加的带宽。


从芯粒到系统:A*STAR面向AI封装的全面异构集成策略
随着AI模型扩展到万亿参数规模,传统的单片SoC设计再也无法跟上不断升级的性能和功耗需求。AI硬件的未来需要转向模块化芯粒、异构集成和系统级共封装架构。为此,新加坡科技研究局(A*STAR)正利用其微电子研究所(IME)平台,构建一个从芯粒和中介层到光子引擎和热模块的、完全集成的先进封装路线图。
“一站式”异构集成挑战:平衡能效与系统复杂性
关键行业差距:
·缺乏一个集成芯粒堆叠、光子耦合、大尺寸中介层和大功率热解决方案的综合平台。
·AI系统需要多芯片集成(XPU、HBM、光子器件、供电单元),这极大地增加了封装复杂性和可靠性要求。
·孤立的组件优化无法转化为系统级能效。
A*STAR的全栈解决方案:面向高能效AI系统的先进封装
1. 芯粒堆叠:通过混合键合实现3D-IC
·利用芯片对晶圆(C2W)和晶圆对晶圆(W2W)混合键合
·通过CSAM成像、MSL3和TCoB测试合规性验证可靠性
·在紧凑的3D结构中支持高频逻辑、HBM存储器和光子模块
2. 大型重构2.5D中介层
·采用重构中介层架构,突破光罩尺寸限制(>5倍),实现大尺寸封装
·支持多桥接架构,实现多个XPU + HBM模块的聚合
·允许更高的I/O密度和多模块信号集成
3. 共封装光引擎(CPO)
·将>6.4 Tbps的光引擎直接集成到封装中
·结合硅光电子学和驱动器/TIA电路
·实现超高带宽、低延迟互连,非常适用于AI集群和数据中心节点
4. 热管理:硅微冷却器
·利用能够处理>2kW热通量的微结构硅冷却器件
·在ECTC 2025会议第12.1分会场展示的实验数据已验证其性能
·专为具有严格热预算的堆叠式高功率AI芯粒而设计
IME的集成先进封装生态系统
“解决方案:IME拥有完善的先进封装产线,以弥合将异构组件集成到高能效系统中的差距”这不仅仅是一系列封装技术的集合——它是一个模块化、以系统为中心的平台,通过中介层设计、材料集成、光学耦合和热解决方案,将XPU、HBM、光子集成电路和供电单元等异构组件连接成一个紧密的架构。
该方法从组件级创新转向系统级优化,为代工厂、外包封装测试厂(OSAT)和系统集成商,以及寻求原型制作和试生产支持的AI硬件初创公司和ASIC设计团队提供了巨大价值。
A*STAR IME:下一代AI系统封装的关键节点
无论您是在开发支持CPO的引擎、构建基于芯粒的架构,还是解决高散热功率集成挑战,ASTAR IME的平台正在从单点解决方案向系统级部署演进。随着AI系统架构进入重新定义的新阶段,ASTAR IME作为下一代创新的关键推动者,在全球先进封装生态系统中架起了技术、领域和合作伙伴之间的桥梁。

新加坡半导体生态体系覆盖全价值链:构建亚洲最全面的异构集成基地
随着半导体产业进入以先进封装和异构集成为标志的新时代,从材料、设计到制造和测试的每个阶段都需要深入的技术协同。虽然新加坡可能不是全球最大的晶圆生产地之一,但它凭借其国际视野、研发实力和政策稳定性,迅速建立了一个完整且协作的半导体价值链。该生态体系涵盖:
·材料
·设备
·无晶圆厂公司 / IDM(集成器件制造商)
·OSAT / 代工厂(封装、测试和制造服务)
下文展示了新加坡如何利用全球企业和本地创新机构的融合,成为亚洲最具战略整合性的半导体中心之一。
四大产业支柱及其代表性企业
1.材料
新加坡是许多世界领先材料供应商的所在地,包括:信越化学(Shin-Etsu)、东丽(Toray)、富士胶片(FUJIFILM)、英特格(Entegris)、贺利氏(Heraeus)、HD MicroSystems、旭化成(Asahi Kasei)、积水化学(Sekisui)、Teracircuits等。
这些公司提供了从光刻胶、封装材料、热界面介质到硅晶圆和下一代低k介电质的完整供应链——为先进封装和光子集成奠定了基础。
2.设备
一个强大的设备供应商生态系统支持从前端晶圆制造到后端组装的工艺:应用材料(Applied Materials)、泛林集团(LAM)、阿斯麦(ASML)、EVG、迪思科(Disco)、ASM太平洋科技(ASMPT)、Capcon、爱发科(ULVAC)、牛津仪器(Oxford Instruments)
新加坡在光刻、沉积、化学机械抛光(CMP)、切割、组装和测试方面拥有能力,使该国能够在先进封装、混合键合和硅光电子集成工具方面进行内部合作。
3.无晶圆厂 / IDM(设计)
许多全球设计公司和IDM已在新加坡设立研发和制造中心:英特尔(Intel)、超威半导体(AMD)、英飞凌(Infineon)、意法半导体(STMicroelectronics)、美光(Micron)、西部数据(Western Digital)、Qorvo、POET Technologies、美满电子(Marvell)、铠侠(Kioxia)、思佳讯(Skyworks)。Lightspeed Photonics等初创公司专注于CPO/OIO和集成光子学,将新兴技术与商业应用联系起来。这些实体与IME的研发产线一起,实现了从架构到原型开发的端到端产品实现。
4.OSAT / 代工厂
新加坡的后端制造生态系统高度成熟,支持先进封装的开发和产业化:格罗方德(GlobalFoundries)、联华电子(UMC)、星科金朋(STATS ChipPAC)、DEPI、amf、TAC、Rapidus。这些参与者为2.5D/3DIC、扇出型晶圆级封装(FOWLP)、C2W/W2W混合键合以及类CoWoS集成提供了平台。
结合A*STAR的中试线和光电子HI能力,该生态系统提升了AI系统模块的密度和能效。
学术与研究支持:新加坡国立大学(NUS)、南洋理工大学(NTU)、新加坡科技设计大学(SUTD)和A*STAR的作用
新加坡高等教育与国家研究政策的紧密结合,实现了“人才即产业”的模式。
·新加坡国立大学(NUS)、南洋理工大学(NTU)和新加坡科技设计大学(SUTD)在材料科学、光子学、AI SoC设计和封装技术方面贡献前沿研究。
·A*STAR作为国家协作创新平台,提供中试制造、工具链集成、设计验证和测试平台——为异构集成打造了一个密集且可扩展的生态系统。
从“硅岛”到系统级封装创新的全球核心
这个价值链图清晰地表明,新加坡并非在孤立的节点上竞争——它正在协调全链协同。
在全球半导体供应链变动的背景下,新加坡正将自身定位为系统级封装和异构集成的战略枢纽,实现从材料、设计到制造和验证全栈的本地原型制作和全球可扩展性。
这就是后摩尔时代的新竞争优势,创新将不再由晶体管微缩定义——而是由架构重构和集成智能定义。
*原文出处:Semi Vision
*原文链接:
https://tspasemiconductor.substack.com/p/astraccelerating-r-and-d-in-heterogeneous
相关阅读

芯启未来,智创生态

















