
【编者按】
本文编译自Semi Vision,深度解析全球半导体设备供应链在AI/HPC时代的技术重构与地缘博弈。随着摩尔定律放缓,先进封装成为性能提升的关键路径,2.5D/3D集成、混合键合(Hybrid Bonding)、CoWoS等技术正重塑设备商竞争格局。文章从前端WFE垄断格局、后端封装设备崛起、材料创新、地缘政治风险等多维度,剖析TSMC、三星、英特尔等巨头的战略布局,揭示设备商如何在技术集中与地域分散的双重趋势中寻找平衡,为读者提供全球半导体供应链变革的全景视角。欢迎感兴趣的朋友转发与关注!
先进封装市场趋势与需求

人工智能与高性能计算推动2.5D/3D封装发展
人工智能和高性能计算(HPC)的需求正加速2.5D/3D封装及HBM存储技术的普及,混合键合与热压键合(TCB)已成为关键工艺。CoWoS(晶圆基底芯片)和SoIC(系统整合芯片)等解决方案实现了同一封装内逻辑芯片与HBM存储的高带宽互联。设备厂商正加大研发投入,以支持更微间距的混合键合与先进热压键合工艺。
设备市场快速增长
至2030年,热压键合设备市场规模预计达9.36亿美元,混合键合设备有望增长至3.97亿美元。倒装芯片和芯片贴装机仍是高产量封装的核心设备,而引线键合则在汽车、工业控制等成本敏感市场保持稳定增长。
地缘政治驱动供应链重组
后段设备供应链正面临关税、出口限制和地区产业政策的挑战。为降低风险,供应商采取地理多元化、技术合作与本地化生产等策略。美欧正建立先进封装研发中心,中国台湾地区的企业(台积电、联电、日月光)也积极投资海外封装产能。报告同时指出,中国国内设备目前仅满足不到14%的需求,成熟生态系统预计2030年后才能形成。
全球化环境下的供应链战略
设备厂商策略
• 产品组合多元化:
为应对市场波动及单一客户依赖,晶圆厂设备(WFE)与后段设备供应商正扩展产品与应用组合。例如阿斯麦(ASML)除标准EUV光刻机外推出高数值孔径EUV;应用材料(Applied Materials)与法国CEA-Leti合作开发新材料,并投资Besi以增强封装设备能力。
• 战略联盟与投资:
应用材料入股Besi象征着前段与后段设备供应商的融合。东京电子(TEL)与比利时微电子研究中心(imec)延长合作以加速2纳米以下制程研发。在封装领域,韩美机械(Hanmi)和韩华集团(Hanwha)竞逐热压键合市场,而Besi的热压键合设备与ASMPT的混合键合工具均获强劲订单。
• 地理多元化与本地化:
为降低出口管制与物流风险,供应商在北美、欧洲、日本及东南亚建立工厂与服务中心。中国台湾、韩国和美国的晶圆厂也要求供应商设立就近支持中心以增强供应链韧性。
晶圆厂与封测企业策略
• 跨境投资与供应链分散化:
台积电与英特尔在亚利桑那州和俄亥俄州建厂,三星在得州泰勒市新建晶圆厂以获取《芯片法案》补贴并贴近客户。联电在新加坡扩大12英寸产能,并与合作伙伴共建先进封装产线。
• 自主研发先进封装:
台积电建设大规模先进封装工厂以扩展CoWoS和SoIC平台。三星将先进封装研发转移至制造基地附近,聚焦混合键合与HBM技术。英特尔将封装服务定位为其代工业务的核心收入来源,并扩大混合键合产能。
• 区域生态与政府合作:
美日欧政府支持先进封装中试线建设。据DQIndia报道,供应商正与政府及学术机构合作强化区域能力,并利用补贴建立生产基地。
全球化挑战下的影响与展望
• 短期波动与长期机遇:
主流消费电子复苏缓慢曾使后段设备利用率低于60%,但AI与HPC需求正推动新一轮投资潮。2025年后段设备收入预计环比增长32%,一季度达17.4亿美元。
• 供应链韧性成本上升:
地缘政治风险迫使供应商与晶圆厂建立跨区域冗余产能,推高资本支出。出口限制或减缓中国市场增长,但也促使中国加速国产设备研发以逐步提高本土供应比例。
• 封装成为新竞争焦点:
随着摩尔定律放缓,先进封装成为性能提升的关键。台积电、三星和英特尔通过CoWoS、I-Cube与Foveros等平台竞逐。封测企业与设备厂商重要性日益凸显,行业边界逐渐模糊。通过投资与合资,设备供应商正提升封装能力,未来十年预计出现更多跨领域合作与并购。
全球半导体供应链格局
半导体供应链具有高度全球化与技术集中特征。前段设备由阿斯麦、应用材料、泛林、东京电子与科磊主导,台积电、联电、三星和英特尔高度依赖这些供应商。后段封装则由日月光、安靠与长电科技等封测企业主导,设备供应商以迪思科、Besi、ASMPT、库力索法与Semes为代表。AI与HPC对2.5D/3D封装及HBM的需求正在重塑后段设备格局。
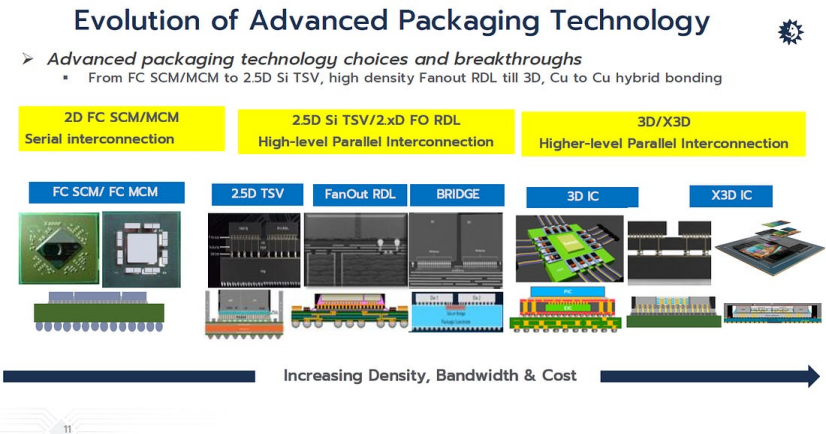
面对地缘政治压力、出口管制与疫情后供应链瓶颈,设备制造商与晶圆厂正通过多元化、战略联盟、地理分散与自主封装研发提升韧性。随着各国政府将半导体供应链安全列为优先事项,未来晶圆制造与封装投资将更趋分散化。封装设备厂商需建立全球研发与制造网络,并与客户共同开发技术以保持竞争力。
CoWoS供应链复杂性
CoWoS是一项创新工艺,我们已简化其流程与供应链关系。目前CoWoS需使用多种材料,中国台湾供应链正积极推动本地化参与,供应商努力取得材料认证。但材料认证涉及可靠性、可重复性与稳定性等多重因素,意味着供应商必须耐心完成漫长的认证流程。
全球供应链管理
CoWoS供应链高度多元化,涵盖设备、材料与集成环节,是半导体领域最复杂的制造生态系统之一。
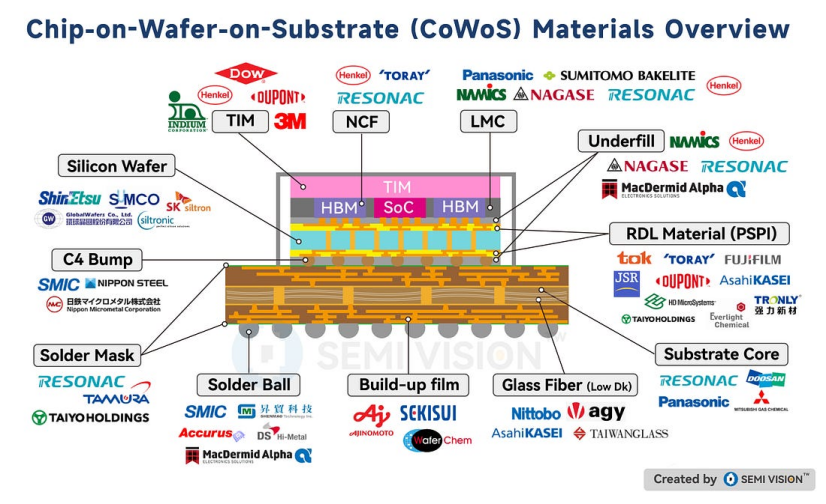
• 挑战:先进封装依赖高度复杂的全球供应链。设备厂商需应对贸易紧张、关税与物流中断问题。此外,来自全球各地的原材料或零部件可能面临短缺或质控问题,影响设备交付时效。
• 机遇:供应链来源多元化与区域制造能力投资可降低风险。例如建立本地生产与服务枢纽有助于缩短交付周期并提升客户支持。
技术进展与CoWoS定位
CoWoS(晶圆基底芯片)的核心目标是为AI芯片提供系统级集成平台。随着AI芯片尺寸快速增长,大尺寸硅中介层使逻辑芯片与HBM存储得以集成,实现更高带宽与更低延迟的性能优势。
然而CoWoS中介层面积受光罩尺寸限制。目前台积电以9.5倍光罩尺寸为阈值,超出该限制后传统CoWoS将面临制造瓶颈。
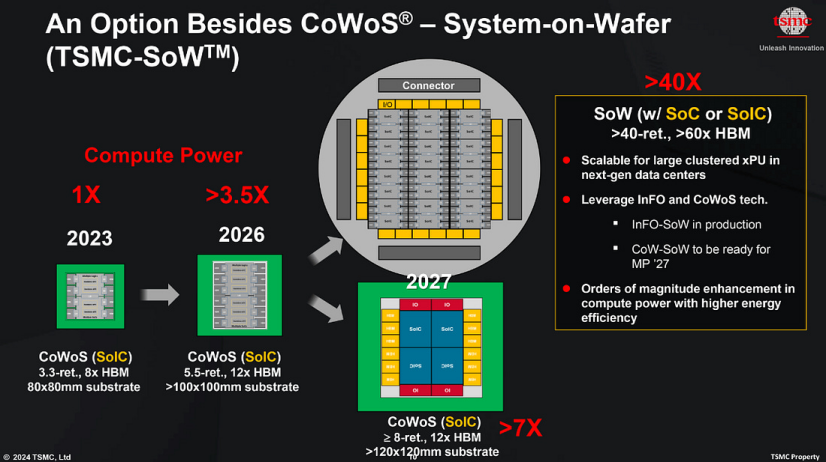
为突破挑战,台积电推动两条替代路径:
1.SoW(晶圆级系统)——以整片晶圆为平台,打破光罩限制,特别适合超大规模AI系统集成。
2.CoPoS(面板基底芯片)——在封装层面提供扩展方案。虽性能密度低于SoW,但成本结构优于CoWoS,是一种创新且可扩展的折衷方案。
尽管CoPoS成本相对较低,仍需综合考虑以下因素:
• 热膨胀系数(CTE)失配
• 封装翘曲
• 电源/信号完整性(PI/SI)
• 基板制造能力
这些挑战使CoPoS成为需要跨供应链协作的复杂技术创新。

相关阅读
*原文媒体:Semi Vision

芯启未来,智创生态















