
【编者按】
本文编译自Semi Vision,深度解析全球半导体设备供应链在AI/HPC时代的技术重构与地缘博弈。随着摩尔定律放缓,先进封装成为性能提升的关键路径,2.5D/3D集成、混合键合(Hybrid Bonding)、CoWoS等技术正重塑设备商竞争格局。文章从前端WFE垄断格局、后端封装设备崛起、材料创新、地缘政治风险等多维度,剖析TSMC、三星、英特尔等巨头的战略布局,揭示设备商如何在技术集中与地域分散的双重趋势中寻找平衡,为读者提供全球半导体供应链变革的全景视角。欢迎感兴趣的朋友转发与关注!
先进封装与硅光集成

台积电长期将先进封装和硅光子技术视为超越制程微缩的第二增长曲线。随着技术从CoWoS→SoW(晶圆级系统)/CoPoS(基板上晶圆上芯片)的演进,下一步方向已非常明确:强化SoIC和3维堆叠技术以提升系统级互连密度。
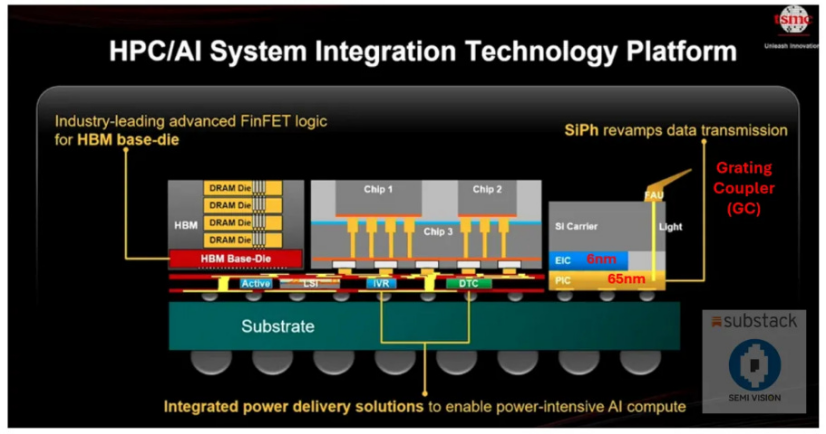
然而随着AI芯片设计日益庞大复杂,单纯的逻辑堆叠已不足够。电源完整性(PI)和信号完整性(SI)的挑战正快速显现。为支撑高速大规模AI计算,台积电与产业界提出了多种器件级解决方案:
• eDTC(嵌入式深沟槽电容):降低供电网络阻抗,增强电源稳定性
• IVR(集成电压调节器):实现芯片级精细电压调控,最小化传输损耗
• IPD(集成无源器件)、MIM(金属-绝缘体-金属电容)及MtM(金属直连):提升信号质量,减少寄生效应
如何将这些元件高效集成于先进封装之中,已成为台积电和行业研发的核心焦点。越来越多技术论文指出,未来将围绕系统技术协同优化(STCO)展开。
从铜互连到光互连:材料与物理极限

随着传统铜互连在带宽和功耗方面面临根本性物理极限,光学I/O已成为必然替代方案。关键挑战在于实际部署:
• 技术成熟度:需要完整解决方案,从光引擎演进到CPO(共封装光学)和LPO(线性可插拔光学)等标准化模块
• 客户接受度:部署速度将很大程度上取决于超大规模企业和AI芯片制造商的实际应用情况
目前主要厂商已开展实际验证:
• 英伟达通过其CPO交换机展示了光互连的高性能应用

• 博通和迈威尔正在以太网和SerDes领域推进共封装光学集成


这些突破凸显了一个核心现实:硅本身存在固有局限,使得寻找下一代"硅基替代者"成为当务之急。

从台积电公布的技术路线来看,硅光子技术已有明确应用方向——特别是采用混合键合技术将光子集成电路(PIC)与电子集成电路(EIC)集成的光引擎。但台积电当前重心仍主要集中于硅基光子技术。与此同时,我们观察到全球领先代工厂正积极布局非线性光学(NLO)应用领域。这些领域极其复杂,正使NLO成为日益重要的研发课题。

非线性光学与材料创新
非线性光学(NLO正日益被视为极具前景的发展方向。其核心在于利用新材料特性突破光传输和信号调制方面的性能瓶颈。但由于晶圆厂长期依赖纯硅工艺,新材料的引入(如铌酸锂、III-V族化合物或薄膜铌酸锂)面临重大挑战:
• 工艺整合:防止异质材料污染
• 良率控制:确保多材料工艺一致性仍是障碍
• 成本效益:NLO组件需在系统层面实现可行的成本结构
目前欧美及中国的多个论坛和产学研合作正积极推动非线性光学应用,更广泛的产业生态也开始探索跨材料合作的潜力。
我们注意到台积电正在持续推进其CMOS工艺技术。简而言之,2纳米节点以下的CMOS微缩带来几个关键转变——总结来看,台积电正处在三大战略轴线的交汇点:
• 先进制程技术(N2→A16/A14):向GAA和BSPDN转型
• 先进封装(SoIC、3D堆叠):系统级优化
• 光电互联与材料创新(CPO、非线性光学):下一代突破

这三个方向将共同决定台积电能否在AI基础设施时代保持领导地位,并将深刻影响全球半导体产业的技术演进。
• 挑战:半导体制造商日益追求更快的上市时间和更集成的解决方案。设备供应商必须快速适应5G、AI和汽车电子等领域客户需求的急速变化
• 机遇:通过紧密贴合客户并理解其演进中的需求,供应商可开发高度契合行业趋势的产品。这种以客户为中心的方法将构建长期合作关系与信任
总之,先进封装设备商可通过聚焦技术创新、成本效益、可持续性和定制化能力,在适应市场变化和客户需求的同时,于全球化格局中开辟成功之路。
相关阅读
*原文媒体:Semi Vision

芯启未来,智创生态















