
【编者按】
本文选自Semi Vision,深度解析SEMICON Taiwan 2025材料论坛的核心议题,揭示AI驱动下半导体行业正从“晶体管微缩”转向“材料革命”。TSMC、ASE、TOK、GlobalWafers等巨头一致认为,EUV光刻胶、方形硅片、SiC中介层、玻璃基板(TGV)、钼互联等材料创新,已成为突破系统性能、互联效率与热管理瓶颈的关键。文章从前沿材料技术、协同开发生态、可持续发展等多维度,勾勒出一幅材料驱动AI算力未来的全景图,为读者理解下一代半导体技术变革提供深度视角。
湾芯展期间的技术论坛涉及晶圆制造工艺、设备与材料、先进封装、化合物半导体,以及AI芯片和IC设计等技术热点和产业趋势,很多在SEMICON台湾论坛上演讲的厂商和嘉宾也会来湾芯展论坛做主题演讲分享。
未来十年由材料驱动的微缩化发展
展望未来,三大关键趋势可能定义下一个十年:
1.逻辑器件转型
从GAA到CFET,逻辑器件在未来20年将经历比过去40年更多的架构变革。接触点和沟道层面的材料创新将决定性能和能效。
2.存储器扩展
HBM、3D DRAM和千层NAND将提供AI所需的存储和带宽。但这些进步将需要新的刻蚀化学物质、介电材料和超低缺陷材料。
3.系统级创新
先进封装、光子学和混合键合将实现异质集成。从PCB级互连向封装级互连的转变将重新定义系统设计,而材料科学将成为这一转变的推动力。
AI已经重新定义了半导体行业的优先事项。旧模式——狭隘地聚焦于晶体管微缩——已不再足够。相反,未来属于那些能够将器件微缩、新材料、先进存储器和颠覆性封装整合成连贯系统的参与者。
材料不再是堆栈底部沉默的赋能者;它们如今是塑造性能、能效和可扩展性的战略差异化因素。AI时代的赢家将是那些掌握了材料科学、器件创新和系统架构之间相互作用的企业。
正如FinFET的引入曾重新定义了一代逻辑器件一样,即将到来的材料突破浪潮——从钼互连到金刚石基板和硅光子学——将重新定义AI硬件的未来。该行业正站在一个新范式的门槛上:一个为AI时代服务的、由材料驱动的摩尔定律。

AGC:将玻璃解决方案整合到先进封装中

AGC对半导体的广泛贡献
AGC的足迹遍布众多半导体应用领域:
·前道贡献:
o均投入大规模生产的EUV光罩空白基板和合成石英玻璃。
o用于高纯度、低膨胀热处理夹具的碳化硅陶瓷。
·后道贡献:
o为匹配先进设计规则而设计的CMP浆料。
o采用TGV技术实现精细微孔间距的玻璃核心基板。
o具有定制热膨胀系数以抑制异质集成中翘曲的载板玻璃。
o具有超低介电常数和损耗角正切的积层薄膜和覆铜板。
o应用于工业和半导体开发领域的二氧化硅填料(中空用于低介电常数,实心用于低损耗角正切)。
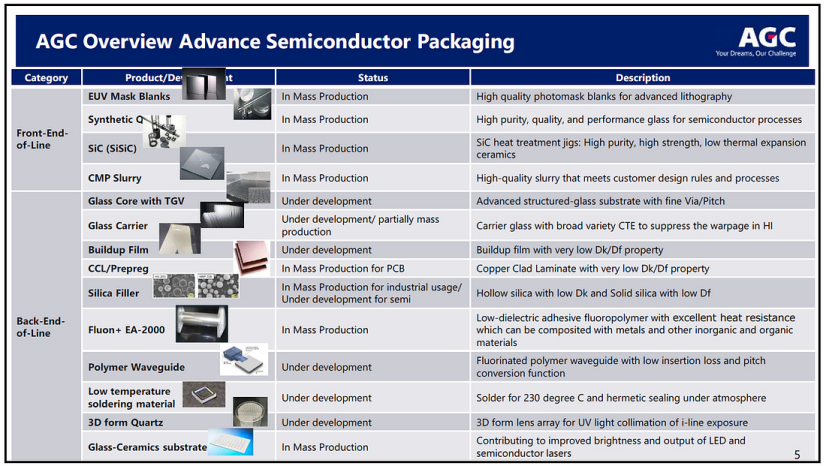
除此之外,AGC还开发低介电粘合剂、聚合物光波导、低温焊接材料以及用于高亮度LED和半导体激光器的玻璃陶瓷基板。这种多样化的产品组合支持从扇出型封装和中介层到共封装光学中光学互连的各种应用。
玻璃核心技术的发展路径
AGC大约在2010年开始与佐治亚理工学院合作研发TGV技术,旨在降低硅中介层的成本。在接下来的十年中,AGC制定了坚实的路线图:
·2012–2017年: 从6英寸/8英寸/12英寸晶圆扩展到大型玻璃基板,目标针对中介层和再布线层封装。
·2017–2020年: 应用扩展至射频器件,如集成无源器件、固定无线接入和天线封装,推动了5G基础设施对TGV的需求。
·2020–2025年: 掌握高速钻孔技术,实现针对厚度大于1毫米玻璃的高深宽比通孔。
·2025–2035年路线图:
o在数据中心AI中采用玻璃核心基板进行小芯片封装。
o集成光学互连以实现共封装光学。
o展望至2050年,实现结合光子集成电路、玻璃光波导和聚合物波导的1 Tb/s光子学系统。
AGC的长期路线图反映了从电互连向电+光混合互连的转变,从而实现更高频率、更低损耗以及与光子学的集成。
用于封装的玻璃之关键特性

玻璃因其可调节的成分和结构而具有独特的适应性。AGC利用其材料专业知识来优化:
·热膨胀系数可变性: 允许基板设计者在应力和结构完整性之间取得平衡。
·介电性能: 低损耗玻璃选项性能优于传统覆铜板,对高频和毫米波应用至关重要。
·表面与厚度控制: 对于光子级基板,TGV精度可达20微米,总厚度变化小于1微米。
·机械强度: 定制杨氏模量并最小化翘曲。
例如,EN-A1和合成石英AQ适用于需要高TGV精度的5G芯片基板,在高于80 GHz及光子应用中有更严格的要求。
玻璃通孔与金属化挑战
TGV是玻璃核心基板的支柱。AGC根据应用优化通孔形状——直形、锥形或X形。然而,真正的复杂性在于金属化,玻璃在此提出了独特的挑战:
·确保种子层的阶梯覆盖率。
·实现铜与玻璃之间大于4牛/厘米的附着力。
·防止空洞、凹陷和裂纹。
·保持均匀的铜厚度和CMP平坦性。
AGC在化学镀铜方面已展现出强劲成果,在厚玻璃基板上实现了85%的阶梯覆盖率和5.3牛/厘米的剥离强度。该公司正在建立标准工艺流程,该流程整合了玻璃成分、钻孔、金属化和检测,以降低基板制造商采用该技术的风险。
可靠性测试与大规模制造考量
为实现大规模制造,AGC对玻璃基板进行严格的JEDEC可靠性测试:
·温度湿度偏压测试。
·高低温存储测试。
·温度循环测试。
·带偏压的高加速应力测试。
·焊料回流应力测试。
这些测试确保了在实际条件下的稳健性,但可靠性深受玻璃类型、种子层、电镀工艺及下游热过程之间相互依赖关系的影响。AGC对统一标准工艺流程的重视反映了其对良率优化和总拥有成本的关注。
战略展望:玻璃作为AI及未来的平台
玻璃核心基板的应用日益与AI数据中心、高性能计算、5G/毫米波射频和光学互连紧密相连。通过提供低损耗、高精度和混合兼容的基板,AGC将玻璃定位为有机基板乃至硅中介层的天然继任者。
近期,小芯片封装和射频天线封装将推动其应用。到2030年代,共封装光学和光电混合集成将定义玻璃在高性能计算和网络中的作用。长期来看,玻璃基板可能推动行业从电子向光子的过渡,支持太比特级互连。
AGC在SEMICON上的演讲强调了玻璃材料如何逐渐成为半导体封装创新的核心。通过将一个世纪的材料专业知识与前瞻性的路线图相结合,AGC正在应对微缩复杂性和系统级性能的双重挑战。
该公司的愿景很明确:玻璃不仅仅是另一种材料选择,而是一种平台技术,能够实现小芯片、先进射频和光子学集成。成功不仅取决于解决像TGV金属化这样的技术障碍,还取决于确保可制造性、可靠性和成本效益。
随着行业进入AI时代,AGC的玻璃技术可能被证明是基石,连接当今的封装限制与未来的光子学未来。
相关阅读
原文媒体:Semi Vision
原文链接:tspasemiconductor.substack.com

芯启未来,智创生态











