
【编者按】
本文选自Semi Vision,深度解析SEMICON Taiwan 2025材料论坛的核心议题,揭示AI驱动下半导体行业正从“晶体管微缩”转向“材料革命”。TSMC、ASE、TOK、GlobalWafers等巨头一致认为,EUV光刻胶、方形硅片、SiC中介层、玻璃基板(TGV)、钼互联等材料创新,已成为突破系统性能、互联效率与热管理瓶颈的关键。文章从前沿材料技术、协同开发生态、可持续发展等多维度,勾勒出一幅材料驱动AI算力未来的全景图,为读者理解下一代半导体技术变革提供深度视角。
湾芯展期间的技术论坛涉及晶圆制造工艺、设备与材料、先进封装、化合物半导体,以及AI芯片和IC设计等技术热点和产业趋势,很多在SEMICON台湾论坛上演讲的厂商和嘉宾也会来湾芯展论坛做主题演讲分享。
构建生态系统:方形晶圆与12英寸碳化硅
尽管技术不断进步,GWC(环球晶圆)承认生态系统准备度仍是瓶颈。适用于方形硅晶圆和12英寸碳化硅晶圆的自动化工艺设备仍在开发中。这需要与设备供应商、材料供应商和终端客户共同定义工具配置、工艺控制和计量标准。
该公司呼吁建立全球SEMI标准以确保互操作性并加速应用推广。正如300毫米硅晶圆标准化定义了现代晶圆厂时代,建立方形与碳化硅晶圆的生态系统标准将释放其全部经济和技术潜力。
战略意义
从分析师视角看,GWC的技术路线图不仅体现了渐进式改进——更凸显了衬底领域的两大结构性变革:
1.方形晶圆应用:直接提升先进封装中的空间利用率和芯片布局密度,可能取代12英寸硅中介层,并与玻璃核心衬底展开竞争。
2.碳化硅中介层:为解决AI数据中心、电动汽车功率模块和高性能计算中日益严峻的热管理瓶颈提供新路径——这些领域正是传统硅或有机衬底的薄弱环节。
两项创新共同印证了更广泛的行业趋势:衬底不再是被动的载体,而是主动的性能赋能者。无论是在控制翘曲、散热还是互连密度方面,衬底正逐步走向半导体创新的中心舞台。
环球晶圆针对310×310毫米方形硅晶圆和12英寸碳化硅晶圆的大规模量产准备,显示出其对未来五年市场应用前景的强烈信心。成功与否将取决于生态系统协同、成本竞争力以及在良率和可靠性方面的显著优势。
若这些障碍得以突破,方形晶圆与碳化硅中介层可能成为AI和功率电子时代的基石,重塑供应链并在半导体封装行业创造新的竞争格局。

日月光:AI时代的核心——先进封装与材料创新
日月光强调,先进封装与材料创新正成为推动AI革命的核心支柱。随着行业从晶体管微缩定义的时代转向系统级集成驱动的新阶段,越来越明显的是,仅靠摩尔定律已无法满足计算需求的指数级增长。公司指出,虽然晶体管和逻辑缩放仍然重要,但AI硬件的根本瓶颈不再局限于硅本身,而是转向三个相互关联的领域:系统级性能、互连效率和电源管理。

首先,系统级性能日益受限于将多个高性能芯片(如GPU、CPU、AI加速器和高速堆叠存储器)集成至单一封装的需求。这种异构集成在良率、可靠性和可扩展性方面带来挑战,但对满足万亿参数AI模型的算力需求不可或缺。
其次,互连效率已成为关键限制因素。传统铜互连面临固有电阻、信号损耗和密度限制,难以维持AI训练和推理工作负载所需的带宽。数据迁移而非原始计算,已成为大规模系统中的主要能耗来源。为此,日月光与行业领导者正投资于细间距混合键合、先进衬底技术、乃至晶圆级光互连集成等解决方案,旨在显著提升带宽,同时降低延迟和每比特传输能耗。
最后,电源管理或许是最紧迫且最显著的挑战。AI加速器单芯片功耗正从400瓦快速攀升至1000瓦以上,预计下一代将达3000瓦。这种功率密度带来前所未有的热管理问题,不仅需要液冷浸没和硅冷板等先进散热方案,更要求热界面材料、抗应力衬底和封装级供电网络实现突破。若缺乏封装与材料层面的创新,这些设备将无法实现可靠或经济高效的运行。
性能、互连与功耗这三大瓶颈正在重塑竞争格局。在新环境中,成功不再仅取决于晶体管密度,而更依赖于封测厂、材料供应商和系统集成商在整个生态系统中的协同创新能力。日月光的强调反映了行业共识:先进封装不再是辅助技术,而是AI时代的战略赋能者。

步入AI时代
会议强调世界正无疑迈入AI时代。预测显示AI市场到2030年将逼近1万亿美元,其中高性能计算预计占比约40-45%。移动设备、汽车平台和物联网应用也将吸收AI能力,形成跨行业的广泛需求。

这种需求直接转化为半导体技术要求:算力性能预计近期提升2-7倍,内存带宽提升最高达10倍,互连密度提升一个数量级。但这些增益以功耗为代价——GPU单芯片功耗已从400瓦跃升至1000瓦以上,下一代AI加速器预计将达到3000瓦。

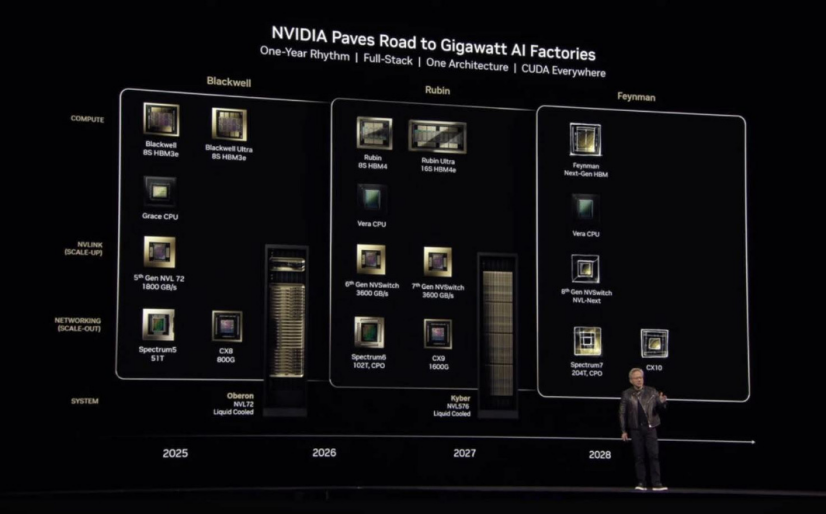

英伟达已宣布推出更强大的平台——Rubin Ultra,预计2027年下半年面世。虽然Vera CPU保持不变,但GPU配置将实现重大飞跃,在NVL576系统中集成高达576个Rubin Ultra GPU。
性能方面,Rubin Ultra的设计目标包括:
• 15 ExaFLOPS的FP4推理性能
• 5 ExaFLOPS的FP8训练能力
• 约为Rubin NVL144系统4倍的计算容量
该系统将支持4.6 PB/s的HBM4e带宽、365 TB高速内存和1.5 PB/s的NVLink7互连吞吐量,CX9网络传输速率达115.2 TB/s——创下基于GPU的计算规模新纪录。
但如此大规模的集成带来功耗与热管理的重大挑战。随着GPU功耗步入数千瓦范围,冷却576-GPU液冷超算集群(如Rubin Ultra)需要在机架设计、液冷基础设施和供电系统方面实现重大创新。行业不仅需评估计算增益,更要审慎考量这种高功耗平台的可持续性与运营效率。

封装技术成为关键赋能者
先进封装已成为平衡性能、功耗与尺寸的核心手段。2.5D硅中介层结合3D堆叠HBM内存已实现30-70%的尺寸缩减和最高10倍的带宽效率提升。扇出型封装、混合键合和TSV集成不再仅是组装解决方案,更成为系统级AI性能的战略赋能技术。

从焊点连接向铜混合键合的转变,体现了行业缩短互连长度、降低电阻和提升可靠性的努力。但挑战依然存在:翘曲、连接点质量和热应力问题不仅需要结构创新,更需开发针对厚胶、高深宽比通孔和强可靠性需求的新型材料。
原文媒体:Semi Vision
原文链接:tspasemiconductor.substack.com

芯启未来,智创生态















