在高性能计算、人工智能快速发展的当下,半导体行业对芯片集成规模和封装基板性能的要求越来越高。过去常用的有机基板在解决大尺寸封装翘曲问题上力不从心,而玻璃基板凭借出色的机械性能、热稳定性和平整度,成为下一代先进封装的“潜力选手”。不过,玻璃基板上的关键结构——玻璃通孔(TGV),却一直被应力问题困扰。
TGV是实现玻璃基板上下电路连通的核心通道,通常需要用铜填充。但铜和玻璃的热膨胀系数差异很大,在封装加工的升温、降温过程中,两者收缩或膨胀的程度不同,会产生巨大的热应力。这种应力可能导致玻璃开裂、铜与玻璃分层,严重影响封装的可靠性和使用寿命。之前行业常用聚酰亚胺(PI)作为缓冲层缓解应力,但PI在高温烧结时容易降解,无法适配后续的化学镀金属化工序,应用受限。
针对这一痛点,中国科学院微电子研究所陈钏团队提出了新方案:在玻璃基板TGV的玻璃与铜之间,烧结一层无机缓冲层。为了适配化学镀工艺,团队选择了ZnO、TiO₂、ZrO₂三种无机材料,通过有限元仿真分析,研究它们对TGV应力的缓解效果,还探索了缓冲层厚度、玻璃芯板厚度等参数的影响。
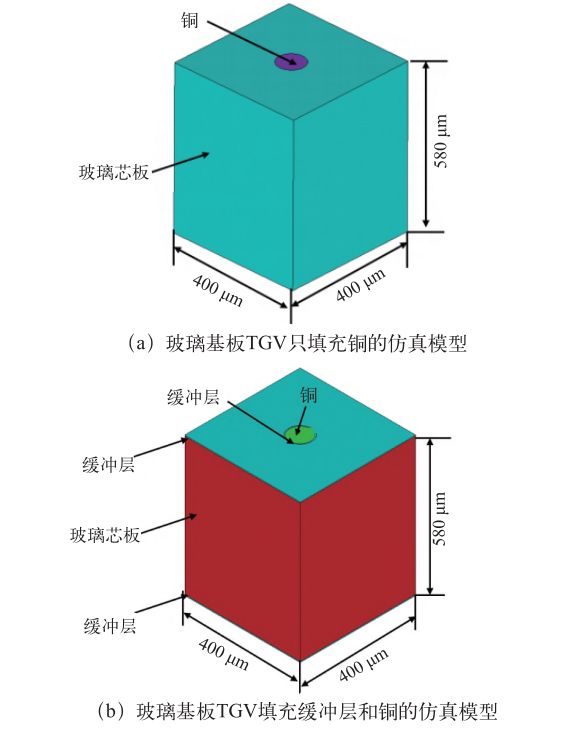
图 玻璃基板 TGV 仿真模型
结论
1)烧结2 μm 及以下的ZnO、TiO₂、ZrO₂无机缓冲层在冷却至室温后玻璃芯板的最大主应力为径向拉应力,最大应力值为 38.41 MPa (2 μm 的 ZrO₂),小于玻璃芯板的抗拉强度 150 MPa,不会造成玻璃芯板的失效。
2)在玻璃基板 TGV 填孔后的叠层工艺升温过程中,加入缓冲层可以有效降低玻璃芯板的应力,最大主应力为通孔内的周向拉应力,纯铜填充的 TGV 玻璃芯板最大主应力为 202.36 MPa,其中应力缓冲效果最好的缓冲层为 TiO₂,缓冲层为 5μm 的 TiO₂,玻璃芯板的最大主应力为 67.63 MPa,相较于纯铜填充 TGV,应力降低了 66.58%。
3)随着缓冲层厚度的增加,玻璃板升温过程中的最大主应力变小,玻璃芯板降温过程中的最大主应力变大;缓冲层厚度从 1μm 增加到5μm,ZnO、TiO₂、ZrO₂ 无机缓冲层的应力缓冲效果明显好于 PI缓冲层通过增加厚度缓解玻璃芯板应力的能力越强,工艺容差大。但是随着缓冲层厚度的增加,所有材料的应力缓冲率整体呈现逐渐下降的趋势,说明应力缓冲效果随着厚度的增加呈收益递减特性。

图 PI缓冲层厚度对玻璃芯板最大主应力的影响
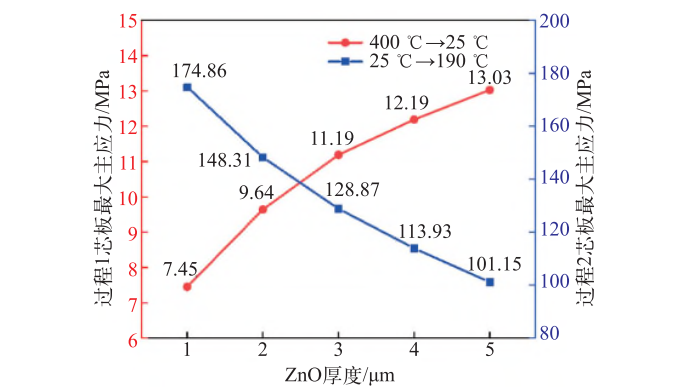
图 ZnO缓冲层厚度对玻璃芯板最大主应力的影响

图 TiO₂缓冲层厚度对玻璃芯板最大主应力的影响

图 ZrO₂缓冲层厚度对玻璃芯板最大主应力的影响
4)随着 TGV 孔径的增加,TGV 降温过程玻璃芯板最大主应力变小,升温过程玻璃芯板的最大主应力变大。
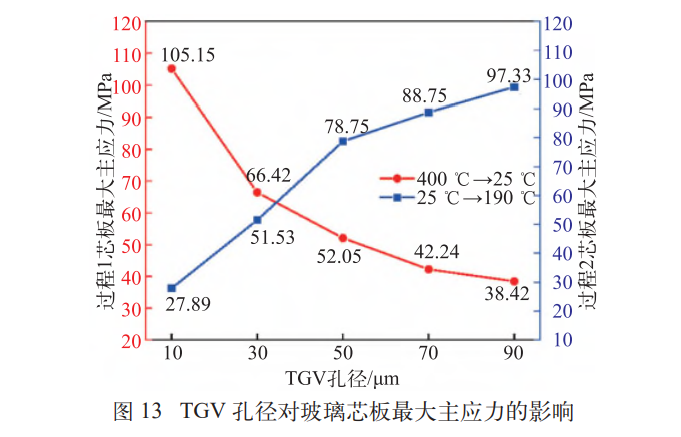
图 TGV孔径对玻璃芯板最大主应力的影响
以上仿真结果表明,无机缓冲层方案可有效降低玻璃基板 TGV 的应力。值得注意的是,玻璃基板加工中,无机缓冲层可能会有高应力断裂失效风险,其抗拉强度以及与玻璃、铜之间的结合力还需在未来工作中进一步研究。
更多仿真实验具体数据可以查看赵泉露,赵静毅,丁善军等《降低玻璃基板 TGV 应力的无机缓冲层方法与仿真分析》论文内容。
DOI:10.16257/j.cnki.1681-1070.2025.0159

包括但不仅限于以下议题
序号 | 议题 |
|---|---|
1 | TGV玻璃核心技术的挑战与解决方案 |
2 | 玻璃基板先进封装技术发展与展望 |
3 | 三维封装硅通孔与玻璃通孔技术发展及应用 |
4 | 先进封装对玻璃基板基材的要求 |
5 | 无机玻璃材料的本构模型、破坏机理及其在工程中的应用 |
6 | 玻璃基互连技术助力先进封装产业升级 |
7 | 真空镀膜设备在玻璃基板生产加工中的关键作用 |
8 | 玻璃芯板及玻璃封装基板技术 |
9 | 玻璃通孔结构控制、电磁特性与应用 |
10 | 玻璃基板及先进封装技术研究与应用 |
11 | 如何打造产化的玻璃基板供应链 |
12 | 电镀设备在玻璃基板封装中的关键作用 |
13 | 玻璃基FCBGA封装基板 |
14 | 显微镜在半导体先进封装缺陷检测中的应用 |
15 | 激光系统应用于TGV制程发展 |
16 | Panel level激光诱导蚀刻 & AOI |
17 | 利用激光诱导深度刻蚀技术实现集成多种功能结构玻璃基板加工 |
18 | FLEE-TGV助力先进封装玻璃基板发展 |
19 | 在玻璃基板上开发湿化学铜金属化工艺 |
20 | 异构封装中金属化互联面临的挑战 |
21 | 电化学沉积法制备TGV-3D互连结构 |
22 | 高效RDL制造技术:赋能多种互联结构的面板级封装 |
23 | TGV金属线路制作的工艺难点及技术解决路径 |
24 | 玻璃基光子解键合技术 |
25 | 基板积层胶膜材料 |
26 | 面向先进封装的磨划解决方案 |
27 | 多物理场仿真技术在玻璃基先进封装中的应用 |
28 | 玻璃基片上集成无源 |
29 | 基于TGV的高性能IPD设计开发及应用 |
30 | 下一代ABF载板-玻璃基及其潜在的机遇与挑战 |
31 | 面板级键合技术在FOPLP中的应用 |
更多相关议题征集中,演讲及赞助请联系李小姐:18823755657(同微信)
报名方式一:扫码添加微信,咨询会议详情
李小姐:18823755657(同微信)
邮箱:lirongrong@aibang.com

注意:每位参会者均需要提供信息
方式二:长按二维码扫码在线登记报名
或者复制网址到浏览器后,微信注册报名
https://www.aibang360.com/m/100272
阅读原文,点击报名