
芯德半导体是一家半导体封测技术解决方案提供商,主要从事开发封装设计、提供定制封装产品以及封装产品测试服务。
公司业务
自2020年9月成立以来,芯德半导体积极拓展先进封装领域,累积丰富的封装技术经验,并具备先进封装的量产能力,涵盖QFN、BGA、LGA、WLP及2.5D/3D等。公司是国内少数率先集齐上述全部技术能力的先进封装产品提供商之一。依托高级管理层的经验及研发部的技术实力,我们搭建起复盖先进封装领域所有技术分支的「晶粒及先进封装技术平台(CAPiC),“以推进公司的技术知识,并持续研发前沿技术,包括同质异质芯粒集成光感光电类封装产品及TGV玻基板产品。

招股书显示,芯德半导体的TGV主要涉及先进技术,包括TGV过孔尺寸62.5μm、最小过孔间距165μm、过孔间距65μm以及7:1的纵横比。RDL的最小线宽/间距为2/2μm。该设计在47,591μm×29,770μm的扇出单元尺寸内集成5颗裸晶,即4颗HBM和1个SoC。
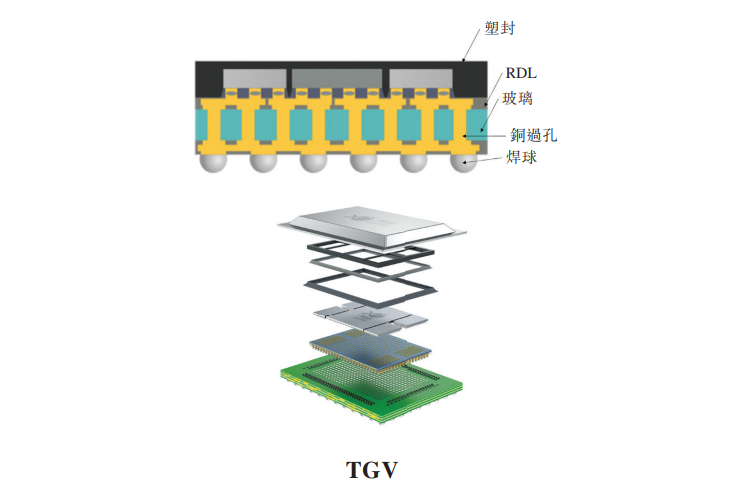
芯德半导体的TGV已顺利完成内部技术验证,目前正与东南大学集成电路学院合作进行工程样品研究。公司于TGV的研发集中在三个主要方向:(a)基于玻璃基板的高性能集成无源元件(IPD);(b)利用玻璃中介层的高级射频模块和相控阵技术;及(c)用于高计算功率GPU的玻璃封装解决方案。
2025年9月,据“芯德半导体”官微消息,公司TGV技术取得突破性进展。
芯德半导体凭借在2.5D封装领域的深厚技术积淀,持续深耕创新。近期,芯德半导体与东南大学史泰龙团队联合研发的晶圆级Glass Interposer 2.5D扇出型封装技术取得突破性进展,相关技术指标均精准达成封装设计需求。本次流片的首颗样品为面向AI加速芯片的2.5D集成模块,该模块包含1颗采用7nm工艺的国产GPU核心、4颗单颗带宽超460GB/s的HBM2E存储芯片,以及厚度为400μm的Glass Interposer互连层,整体架构为高性能AI计算提供了强大的硬件支撑。
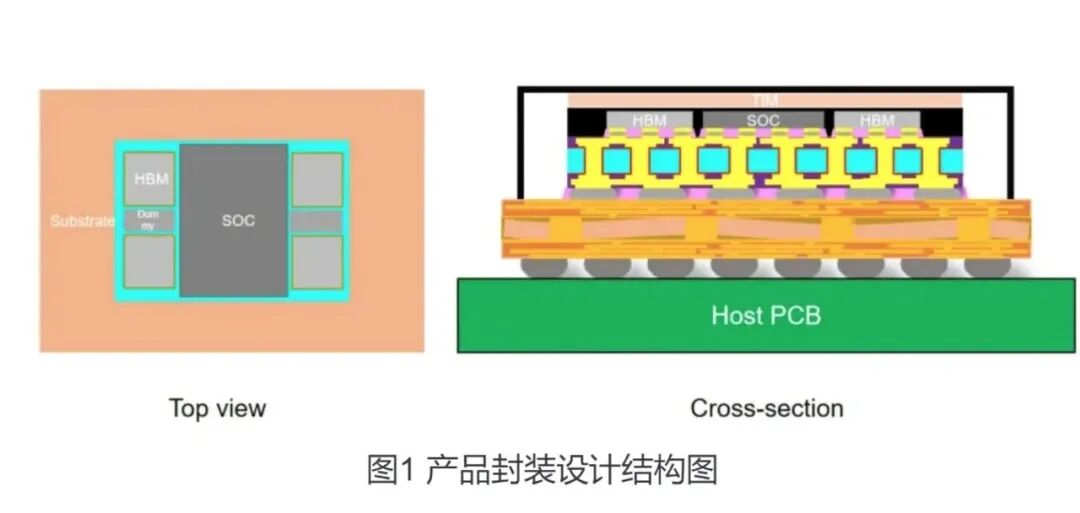

业绩方面
业绩方面,2022年、2023年、2024年及2025年截至6月30日止六个月,芯德半导体实现收入分别约为2.69亿元、5.09亿元、8.27亿元、4.75亿元人民币;同期,年/期内亏损约为3.60亿元、3.59亿元、3.77亿元、2.19亿元人民币。

值得注意的是,芯德半导体的经调整净利润已转正,从2022年的亏损1.54亿元,到2024年的盈利5977万元,2025年上半年盈利5934.3万元。
据了解,芯德半导体5年已经完成超20亿元融资,吸引多家知名机构,其中包括小米长江产业基金、OPPO、南创投等。招股书显示,2025年上半年期末现金达1.49亿元。