
关注公众号,点击公众号主页右上角“ · · · ”,设置星标,实时关注旺材芯片最新资讯
在2026年SPIE先进光刻与图案化大会上,先进光刻技术的未来发展是讨论的热点之一。与会者普遍认为,现有技术在十年后将无法满足需求,那么未来的发展方向是什么?一种途径是提高数值孔径(NA),同时缩短波长。
在周二下午题为“超高分辨率:进一步提升光刻分辨率能力的必然之举”的演讲中,光刻设备制造商ASML的技术执行副总裁Jos Benschop阐述了迈出第一步的必要性。他指出,波长的改变需要对光源、光学元件、掩模、光刻胶以及光刻工艺的其他方面进行相应的调整。
过去,业界已经不断突破数值孔径的极限。“我们预计这种情况会再次发生,”本肖普在谈到极紫外(EUV)光刻技术时说道。
目前最先进的技术——极紫外光刻(EUV)使用波长为13.5纳米的光来制作小至8纳米的特征图案。最小特征尺寸由分辨率决定,分辨率与波长除以数值孔径成正比。ASML最新的设备数值孔径为0.55,被称为高数值孔径EUV。在演讲中,Benschop谈到了正在研发中的下一代设备。它们的数值孔径将达到0.75,在其他条件相同的情况下,其最小可印刷尺寸将缩小36%,约为5纳米。更高的数值孔径被称为超高数值孔径(hyper NA)。作为对比,过去的各种光刻技术最终都达到了大于1.0的数值孔径,尽管最初的数值孔径小于1.0。
据Benschop报道,ASML已着手推进这项技术的发展。例如,光学制造商蔡司设计了一种透镜组件,其尺寸仅比0.55高数值孔径(NA)工具中使用的透镜略大。ASML计划制造能够容纳超高NA或高NA透镜组件的光刻工具。因此,超高NA透镜可以直接替换现有透镜。
Benschop承认,北美地区芯片尺寸增大的一大挑战是景深减小。这意味着芯片上的图像更容易模糊,从而影响芯片性能和良率。Benschop表示,解决方案在于改进对焦控制。这需要对传感器和其他扫描仪进行改进,或者使用更平坦的晶圆。
Benschop预测,超高通量核酸检测技术的问题将会得到解决。“当需要超高通量核酸检测技术时,它将随时可用。”他说。
在周二由IBM半导体首席图形工程师Allen Gabor发表的题为“ IBM光刻路线图:未来光刻工具和掩模的需求以及避免随机缺陷的光刻胶要求”的演讲中,探讨了一种替代方案。他着眼于下一个波长,重点关注3.1纳米。采用比当前波长短四倍的波长可以带来诸多优势。首先,达到特定分辨率所需的数值孔径更小。因此,景深比使用更长波长时更大。

Gabor指出,重要的是,新的波长能够对光学设计进行调整,并带来其他方面的改进,与使用13.5纳米波长光相比,可将线边缘粗糙度降低20%。线边缘粗糙度降低后,晶圆上的印刷线条更接近理想状态。这一点至关重要,因为晶圆上每一层图案都必须与下方的图案对齐。如果对准偏差过大,或者线条在特定位置发生偏移,则蚀刻穿过薄膜的孔可能会偏离预定结构,导致短路或开路。边缘未对准还可能以其他方式导致器件故障。
Gabor表示,最大限度地减少边缘定位误差是决定波长的关键因素。事实上,在持续缩小特征尺寸的同时降低边缘定位误差,是IBM未来15年光刻技术路线图的主要目标之一。
Gabor指出,完善光刻基础设施仍有大量工作要做。此外,一些问题也必须解决。例如,目前能够反射3.1纳米波长光线的反射镜反射率约为35%至40%。光刻设备在聚焦或引导光线时可能需要多少面反射镜尚不清楚。Gabor在演讲后的问答环节中表示,反射镜的数量在2到10面之间。如果一台光刻设备使用5面反射率为35%的反射镜,那么光源发出的光线将损失99.5%。
避免这个问题的方法是增加反射镜的数量,减少镜子的数量。在技术真正投入使用之前,这个问题以及其他一些问题都必须得到解决。
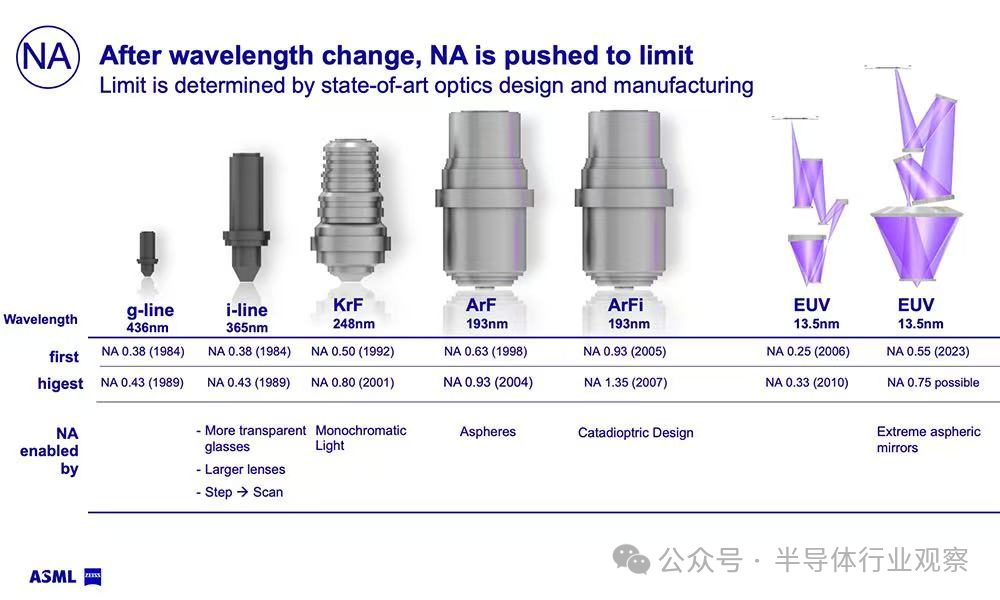
来源:半导体行业观察
专心 专业 专注













